引言
随着尺寸变得越来越小以及使用k值< 3.0的多孔电介质,后端(BEOL)应用中的图案化变得越来越具有挑战性。等离子体化学干法蚀刻变得越来越复杂,并因此对多孔材料产生损伤。在基于金属硬掩模(MHM)开口的低k图案化中,观察到两个主要问题。首先,MHM开口后的干剥离等离子体对暴露的低k材料以及MHM下面的低k材料造成一些损伤。受损低k是非常易碎的材料,不应该被去除,否则将获得一些不良的轮廓结构。其次,连续的含氟低k蚀刻等离子体导致聚合物的形成(图1)。这些聚合物已通过X射线光电子能谱(XPS) 进行了表征,并被发现是碳氟聚合物,很难去除。然而,在不去除受损的低k值的情况下,良好地去除这些聚合物对于获得高产结构是至关重要的。蚀刻后等离子体处理可以去除聚合物,但是通常会导致电介质的k值增加。在不去除受损低k材料的情况下去除聚合物的另一种方法是使用湿法清洗溶液,这一主题将是本文的重点。
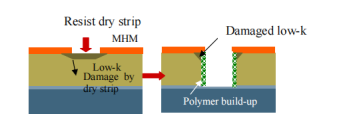
图一。MHM图案化方案和侧壁聚合物的形成。
结果和讨论
含水酸化学物质
所有相容性结果总结在图2中。虚线表示测量误差(厚度为2nm,折射率为0.005,
k值为0.100)。含水酸化学物质似乎与低k材料相容,因为没有观察到重大变化。测定项目A和C产生的k值超出误差线。这些变化可能是一个亲戚的指示不相容,或者也可能是化学成分仍然处于低k值。脱气实验可能会证实这一假设。此外,对于化学物质A(高含量的蚀刻添加剂),观察到折射率略有降低,这表明结构发生了变化(孔隙率增加)。然而,FTIR(图3)分析没有揭示任何结构变化。化学折光率的变化可能是由于测量中的波动。所有含水酸化学物质的FTIR光谱非常相似。
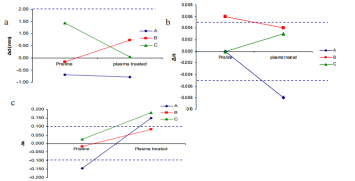
图二。椭偏测量法(d厚度(A),n折射率(B))和k值测量(c),用于在化学物质A、B、c中浸渍后的原始和等离子体处理的低k值。

图3。在化学a中浸泡后原始(左)和等离子体处理(右)低k的FTIR光谱结果。
图案化晶片上的清洗效率也用含水酸化学物质进行评估。HF装饰步骤前后的结果总结在图4中。有趣的是,我们可以观察到蚀刻添加剂的量和清洁性能之间的相关性。如果蚀刻添加剂的量较低,(化学成分C)聚合物的面纱会剥离。这一观察清楚地表明,基于化学的少量蚀刻添加剂是无效的。另一方面,当蚀刻添加剂的量达到中等或高时,在装饰步骤后没有观察到聚合物面纱剥离。这表明聚合物残余物被充分去除。然而,在这种情况下,受损的低k材料(图4,左下)也被去除。
有机溶剂混合物
如前所述,已经对聚合物残留物进行了表征,并发现其为碳氟聚合物。有机溶剂混合物将比含水化学物质具有更好的润湿性能,并且应该能够溶解聚合物。图5总结了等离子体处理的毯式晶片的相容性测试(厚度和折射率)。在椭圆偏振测量中没有观察到大的变化。折射率在测量误差范围内(0.005)。与未经清洗的等离子体处理的晶片相比,观察到厚度略有增加,k值显著增加(+0.3)。清洁之前和之后的覆盖等离子体处理的晶片的FTIR光谱(未示出)没有显示任何结构变化。
蚀刻侧壁后,可以容易地识别聚合物(图7左图)。使用有机溶剂混合物进行清洁测试,不使用兆频超声波功率(图7,中间图片)。在没有兆频超声波的溶剂清洗之后,获得了一些聚合物的去除,但是也观察到了残留物的再沉积。最后,当有机溶剂混合物与兆声一起使用时,观察到聚合物残余物的部分溶解(图7右图)。目前,正在进行更彻底的筛选,以完全清除井壁聚合物。
然而,如图8所示,部分聚合物的去除已经对产出的器件产生了显著的影响。当有机溶剂混合物与记录过程(POR,仅蚀刻)相比时,观察到明显的改善。当使用有机溶剂混合物时,在单镶嵌90 nm间距器件上获得超过95%的产率。
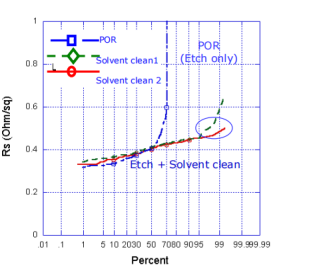
图8。蚀刻和溶剂清洗后SD90图案化晶片上的电产率和可靠性测量。
结论
对含水酸化学物质进行了广泛的研究,并证明了所研究的含水酸化学物质对于蚀刻后残留物的去除并不完全成功。一些聚合物残留物可以被去除。然而,这种去除总是与被破坏的低k的去除相关联。当使用具有少量蚀刻添加剂的含水酸化学物质时,没有聚合物可以被去除。另一方面,纯有机溶剂更有前途。相容性测试是成功,且k值可以通过额外的烘焙步骤来提高。最初的结果令人鼓舞,由于较好的润湿性能,观察到部分溶解。如果使用兆声功率,可以避免聚合物的再沉积。最后,当用有机溶剂混合物进行清洗时,电结果明显改善。
上一篇: 300mm直径硅片湿洗槽出水口设计
下一篇: 半导体封装中金丝键合技术