摘要
本文介绍了再结晶聚对二甲苯首次用作硅化学蚀刻的掩模材料。通过在350℃下熔化聚对二甲苯C 2小时获得再结晶的聚对二甲苯。在不同的温度和浓度下,在不同比例的HNA(氢氟酸、硝酸和乙酸)溶液、KOH(氢氧化钾)溶液和TMAH(氢氧化四甲铵)溶液中测试重结晶的聚对二甲苯的掩蔽能力。发现聚对二甲苯和基底之间的界面会被侵蚀,导致底切。另外,重结晶的聚对二甲苯表现出对硅的良好粘附性、对未暴露的硅的完全保护和与文献数据相当的硅蚀刻速率。
关键词-聚对二甲苯;硅湿法刻蚀;重结晶;
介绍
硅湿法蚀刻工艺应用于传统MEMS结构的制造,例如硅悬臂、硅薄隔膜和其他独立结构。尽管电感耦合等离子体蚀刻或深度反应离子蚀刻(DRIE)可以获得高纵横比的结构,但是硅湿法蚀刻提供了相对便宜、简单和容易的工艺,并且在MEMS领域中仍然是不可或缺的。
硅湿法蚀刻中常用的掩膜,如TMAH和KOH是氧化硅和氮化硅。氧化硅可以通过LPCVD、PECVD或热氧化获得,氮化硅可以通过LPCVD和PECVD获得。这些沉积工艺在某种程度上给整个工艺增加了额外的复杂性和设计挑战。热氧化和LPCVD工艺需要高温,因此在沉积的薄膜中引起应力问题,而PECVD氧化物和氮化物可以通过硅湿蚀刻剂以相当大的速率蚀刻。有时,使用硬掩模根本不可能,因为硬掩模的沉积将不可避免地损坏现有的微结构。
为了解决上述问题,开发了聚合物口罩材料。聚合物掩模作为硬掩模的简单且经济的替代品出现,并提供良好的保护和图案转移能力。
聚对二甲苯或聚(对二甲苯)已经广泛用于许多MEMS应用中。微流体通道、电喷雾注射喷嘴、压力传感器、可植入电极阵列等。已经被证明了。
首先报道了使用重结晶的聚对二甲苯C来提高聚对二甲苯C和载玻片之间的粘附力聚对二甲苯C在氮气环境中被加热到350℃并熔化和再结晶。重结晶的聚对二甲苯C对玻璃具有更强的粘附力,并且仍然可以被氧等离子体蚀刻[6]。然后,本文探讨了再结晶的聚对二甲苯C作为硅蚀刻掩模的能力。
实验细节
A. 样品制备
所有样品都以相同的方式制备。它从优质硅片开始,无论是双面抛光还是单面抛光。硅片首先用异丙醇和丙酮清洗。接下来,用标准的食人鱼溶液清洗晶片,以完全去除有机污染物。在聚对二甲苯沉积之前,将晶片浸入5 wt %的氢氟酸中以清洁表面并去除二氧化硅。
然后通过室温化学气相沉积(CVD)工艺在硅片上沉积不同厚度的聚对二甲苯C。聚对二甲苯的厚度由机器中装载的二聚体重量控制。所有聚对二甲苯二聚物都是从专业涂层系统购买的。不进行进一步的纯化。在聚对二甲苯沉积之后,在充满氮气的炉中加热具有聚对二甲苯的晶片。炉子的瞬时加热曲线是这样的,它以每分钟10℃的速度上升到保持温度350 ℃,并在保持温度350℃保持2小时,最后自然冷却到室温(下降速度小于每分钟2℃)。选择350℃的保持温度和2小时的保持时间,以确保聚对二甲苯C完全熔化和再结晶。
在聚对二甲苯C重结晶后,用常规光刻工艺和反应离子蚀刻(RIE)氧等离子体蚀刻打开蚀刻窗口。这里,值得注意是,再结晶的聚对二甲苯C具有比普通聚对二甲苯C更低的蚀刻速率,通常是普通聚对二甲苯C的0.5倍左右
在形成蚀刻窗口和图案后,将再结晶的聚对二甲苯C涂覆的硅晶片样品浸入各种硅蚀刻溶液中
B. 蚀刻溶液制备
氢氧化四甲铵(TMAH)溶液通过用去离子(DI)水稀释购自适马Aldrich的TMAH 25 wt %溶液来制备。同样的氢氧化钾(KOH)溶液通过用去离子水稀释购自适马Aldrich的45重量%的KOH溶液来制备。氢氟酸-硝酸-醋酸(HNA)蚀刻系统是由49%氢氟酸、98%硝酸和无水醋酸以不同比例混合而成。
回流系统用于TMAH和KOH蚀刻工艺。
C. 测量方法和仪器
底切长度在光学显微镜下测量,蚀刻深度用KLA Tencor P15表面轮廓仪测量。扫描电子显微镜(SEM)也用于进一步确定再结晶聚对二甲苯的表面性质和蚀刻后硅的横截面结构。
结果和讨论
重结晶的聚对二甲苯C具有多晶结构。与一般的parylene C不同,在光学显微镜下,尤其是使用带有偏振光源的光学显微镜时,可以容易且清晰地观察到晶界。图1显示了普通聚对二甲苯和重结晶聚对二甲苯在偏振绿色显微镜下的照片和重结晶聚对二甲苯表面的SEM照片。
从图1中可以看出,在350℃烘烤普通聚对二甲苯C 2小时后出现晶界,并且在加热过程中确实发生结晶。这就是为什么我们称热处理后的聚对二甲苯C为“再结晶聚对二甲苯”。
为了评估再结晶的聚对二甲苯C是否是可靠的硅蚀刻掩模,必须研究几个问题。在这些问题中,诸如聚对二甲苯有多厚应该是提供体面的保护,什么是底切率,如果有的话,什么是相对于硅的蚀刻选择性将在本文中讨论。为了回答这些问题,进行了几个实验。
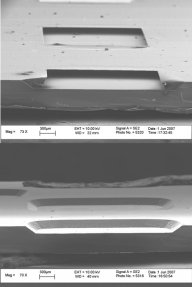
图4。移除再结晶聚对二甲苯之前(顶部)和之后(底部)的SEM照片
通过比较TMAH和KOH的底切速率和硅蚀刻速率,我们发现底切是由蚀刻剂侵蚀聚对二甲苯和硅之间的界面引起的。对于TMAH和KOH,底切速率应该小于硅蚀刻速率,因为这两种蚀刻系统是各向异性的。与诸如热氧化物的硬掩模材料不同,聚对二甲苯和硅之间的粘合比机械粘合更少化学键合。尽管再结晶过程提高了聚对二甲苯对硅的粘附力,但该粘附力仍在范德华力范围内。为了进一步提高重结晶的聚对二甲苯C的掩蔽能力,需要增强聚对二甲苯和硅之间的粘附力。然而,到目前为止,我们还没有找到像聚对二甲苯重结晶那样有效的方法。蚀刻后,再结晶的聚对二甲苯可以通过氧等离子体去除。图4显示了去除重结晶的聚对二甲苯之前和之后的硅样品的SEM照片。
结论
我们演示了使用再结晶的聚对二甲苯作为硅湿法蚀刻的掩模。聚对二甲苯C在氮气环境中于350℃加热2小时后再结晶。确定了为KOH、TMAH和HNA蚀刻系统提供适当保护和底切速率所需的厚度。蚀刻后,再结晶的聚对二甲苯可以用氧等离子体去除。重结晶的聚对二甲苯为硅湿法蚀刻提供了传统硬掩模材料的简单且经济的替代物。
上一篇: 用于选择性蚀刻的加热SC1溶液
下一篇: 从缓冲氧化物蚀刻剂中将铜沉积到硅晶片上