REBL系统被设计成几乎完全数字化,消除了通常与光束偏转和/或整形的模拟控制相关的所有建立时间。使用旋转载物台压板代替更典型的振荡线性载物台,大大降低了载物台开销,导致曝光晶片的总时间提高了近两倍。该系统特别针对45纳米节点平均每小时5至7个晶圆,可扩展至32纳米及以下的商业主流光刻市场。密集图案化级别的吞吐量受到所需模糊的射束电流的限制。对于非常稀疏的水平,吞吐量受到其他系统能力的限制,例如能够实现高达40 wph吞吐量的级。
图1描述了REBL Nanowriter的系统概念。本文将讨论六项核心技术:反射电子光学、数字图形发生器、时域积分、灰度曝光、旋转台和光学晶圆对准。
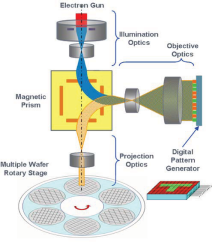
图1
反射电子光学使低压数字图形发生器(DPG)芯片能够独立控制约100万束光束进行大规模并行曝光。这与其他电子束无掩模方法不同,后者通常利用“透射”孔径和消隐阵列来调制具有要在晶片上曝光的图案的光束。
REBL使用光学晶片配准以高通量EBL系统所需的极高速度在晶片上获取配准标记。这种方法不会暴露标记区域上的抗蚀剂,避免了加工过程中对标记的破坏以及随后在误差预算中的附加项。通过这种技术,诸如由电子束加热晶片引起的整体晶片变形实际上被消除了。期望使用已经在集成电路制造中建立的标记来更好地与制造过程集成,并且更好地适应混合和匹配光刻。
REBL Nanowriter的电子光学射线图如图2所示。亮度相对较低的大面积阴极产生照明电子束(蓝色固体射线轨迹)。阴极透镜在聚光透镜的中心形成交叉。聚光透镜在磁棱镜的虚拟中心形成光源的图像。棱镜的虚拟中心是指通过棱镜物理中心的450°对角线上的点,该点与弯曲光轴相交。棱镜被设置成将光轴精确地弯曲90°,并且在x和y平面上建立相等的焦距,并且在x和y轴上具有相等的放大率。当满足这三个条件时,棱镜表现为1:1成像透镜,对从聚光透镜中心到转移透镜中心的交叉进行成像。传递透镜又通过DPG透镜将虚拟棱镜中心的源图像成像到DPG上。
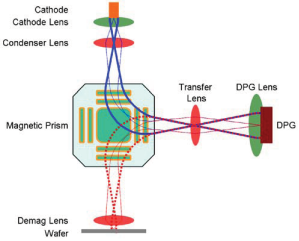
图 2 REBL反射电子光学的射线图
静电DPG透镜有双重用途:它在无穷远处形成交叉的虚像,并使电子减速到阴极电位的几伏以内。当一面镜子在DPG被打开时,它会反射来自照明光束的电子。当这些反射的电子穿过静电DPG透镜的加速场时,它们被重新加速回到棱镜。
REBL的反射技术包括用低能电子照射DPG上的一排小电极,这些电子被DPG透镜减速到大约1电子伏。向整个反射镜阵列施加1-2伏的小负偏压,在该阵列电极正上方的区域产生足够的排斥力,以将照射它的电子反射回DPG透镜重新加速它们远离DPG的区域。当小的正电势施加到一些电极上时,会吸收照射到它们的那部分照明光束。因此,电子图像在图像中对应于吸收电极的点处是“暗的”(即没有电子被反射),而在对应于反射电极的点处是“亮的”。像素是数字的,它们不是开就是关。
晶片计量系统(WMS)是一个由传感器和相关控制电子器件和软件组成的系统,负责测量晶片位置和变形,并保持电子束相对于先前写入的晶片图案的对准。
影响写入精度的主要干扰包括由平台控制误差和残余振动引起的晶片刚体运动误差、热输入引起的晶片变形以及电子束漂移。WMS控制系统依赖于多个传感器,这些传感器以极高的速度高精度地测量晶片上的多个对准标记。
计量系统的一个关键方面是需要参考电子束位置的测量。WMS将获得一组特殊的系统对准标记,用于将WMS与电子束对准,并在工作台上升到写入速度的最初几转中确定每个晶片的位置和方向。在写入过程中,WMS跟踪分布在晶片上的大量(可能每个晶片多达几千个)对准标记。
本文简要回顾了正在开发的用于REBL Nanowriter的核心概念。反射电子光学允许使用一种非常高速的互补金属氧化物半导体专用集成电路芯片,称为数字图形发生器。DPG和写入策略采用了两种技术,称为时域积分和灰度曝光,以实现具有适当剂量的光刻图案放置,用于光盘控制。旋转载物台架构用于消除通常与线性载物台加速相关的障碍,并大大减少开销时间。光学晶片配准结合电子束的频繁校准将提供高通量光刻所需的配准精度和标记获取速度。
上一篇: 通过晶圆键合的硅光子学