本文研究了SiC/GaN通孔刻蚀和通孔环路工艺集成。已经开发了一种新的蚀刻工艺区域,其产生几乎完美光滑的通孔侧壁。最小化通孔蚀刻工艺流程中其他工艺的副作用,以提高通孔质量。
关键词:碳化硅通孔刻蚀,平滑度,通孔侧壁
介绍
近年来,对于半导体工业中用于高功率应用的GaN器件的兴趣已经增加。例如,在2014年CS MANTECH会议上提交的近50%的论文都与GaN相关。GaN具有高击穿电压、高电子迁移率饱和速度[1],使其成为包括高功率、高速和高温微波应用在内的许多应用中非常有吸引力的材料[2-3]。
尽管GaN器件具有优异的电学性能,但在一些器件制造工艺中仍存在自身的挑战。例如,大多数GaN器件是使用SiC作为GaN外延生长的衬底开发的。SiC的蚀刻速率仍然被限制在大约1 μm/min,远低于GaAs的蚀刻速率(GaAs蚀刻速率可以容易地达到~ 6 μm/min或更高)。SiC的低蚀刻速率意味着背面SiC和GaN通孔蚀刻工艺需要坚固的蚀刻掩模。根据蚀刻工艺条件,高达8-10 μm的金属硬掩模用于过孔蚀刻[4,5]。利用金属硬掩模的SiC/GaN通孔形成使得整个通孔形成过程比GaAs通孔更困难。
例如,在蚀刻之后,由于使用某些金属蚀刻掩模,含有金属的蚀刻副产物层会沿着通孔侧壁形成在通孔内部。在SiC蚀刻之后和GaN蚀刻之前,可以使用湿法蚀刻化学品来去除含金属的副产物。然而,这样做也很可能蚀刻掉金属掩模。如前所述[6],在GaN蚀刻之前移除金属掩模可能会在通孔底部引入不期望的切口效应。此外,观察到粗糙的通孔侧壁并不罕见。粗糙的通孔侧壁可能会在通孔内捕获残余物,并在随后的共形通孔侧壁金属化中引起潜在的问题。
因此,优选的是,最小化通孔侧壁上的副产物形成;其次,副产物一旦形成,就可以在不使用湿法蚀刻工艺的情况下被去除,湿法蚀刻工艺还会侵蚀硬掩模或通孔下的金属焊盘。为了能够在没有湿法蚀刻工艺的情况下去除副产物,希望使通孔侧壁光滑,尤其是如果通孔的横向尺寸远小于其深度。通常,较大的通孔直径可以具有较高的蚀刻速率,从而更容易生产。光滑的通孔侧壁将有助于更有效地去除副产物,而无需利用湿法蚀刻工艺。
在本文中,我们报告了一种改进的SiC/GaN通孔形成工艺的结果,该工艺对于100 um厚的SiC衬底中的小直径通孔具有非常平滑的通孔侧壁。
实验
本文报道的大多数工艺研究是在100 mm GaN晶片上进行的,GaN生长在SiC衬底上。在完成正面器件制造工艺之后,SiC衬底然后被研磨和抛光至其最终厚度(通常为50 um至100 um)。在SiC表面上形成各种直径尺寸的通孔图案。通孔金属蚀刻掩模沉积在SiC表面上。在多个生产晶圆上对优化的工艺进行了广泛的评估,以证明工艺的可重复性。
对于SiC/GaN通孔蚀刻,使用具有优化的ICP源的电感耦合等离子体(ICP)蚀刻工具。SiC蚀刻工艺的细节之前已有报道[7-8]。在本研究中,使用许多参数评估了各种新的蚀刻条件,包括反应物组成(不同的气体种类和不同的气体流速)、工艺压力、RF功率和晶片到等离子体源的间距。
使用光学显微镜进行常规通孔检查。为了进行更详细的分析,使用SEM、FIB和EDX分析通孔,以表征通孔形状、通孔侧壁表面形貌和通孔侧壁表面的化学成分。
结果
值得注意的是,样品制备似乎对蚀刻通孔的质量有很大影响。这在图1中示出,其中图1(a)和图1(b)的通孔是在非常相似的蚀刻条件下蚀刻的。
两个样品之间的通孔侧壁基本上不同。这被认为主要是由于通孔蚀刻掩模的变化。图1(a)中所示的通孔硬掩模具有更好限定的圆形形状,而图1(b)中所示的通孔周边的顶表面比图1(a)中的更粗糙。牢记蚀刻掩模的这种潜在变化,使用从同一晶片切割的样品进行随后的蚀刻工艺优化。
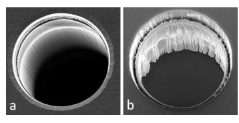
图1 .在相似条件下蚀刻的两个不同晶片的通孔。
图2比较了在两种不同蚀刻条件下从同一晶片上切割下来的样品(这些样品在蚀刻后没有清洗)所蚀刻的通孔。如图2(a)所示,在未优化的蚀刻条件下,通孔侧壁非常粗糙。而图2(b)示出了当蚀刻条件转移到更优化的工艺时,通孔侧壁变得更加平滑。这证明了蚀刻条件对通孔侧壁质量的影响。如图3所示,在整个晶片上重复了在小样品上观察到的蚀刻通孔的改善(图2(b))。
对几个通孔进行剖切,以检查由优化工艺形成的通孔。图4和图5显示了横截面视图的示例。在图4中,通孔内的一些填充材料是成像前研磨工艺的产物。在图5中,顶部是如图4中圈出的与正面金属接触的过孔的一部分;底部是过孔拐角附近的放大图。
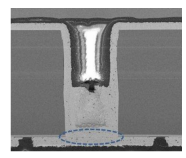
图4。完整过孔的横截面。
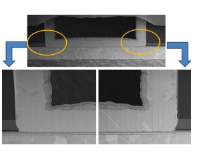
图5。过孔底部的横截面。
图2(a)和图3-5示出了使用优化工艺蚀刻的通孔的侧壁是光滑的,并且通孔的整体轮廓和与前侧金属的接触是极好的。使用EDX的额外分析表明,在温和清洗之后,在通孔侧壁上没有留下明显量的外来材料或副产物。这可以在图6中看到,其中EDX信号仅显示了Si和C的存在,这是SiC的主要成分。
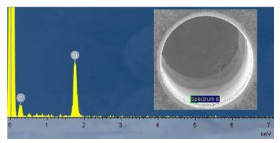
图6。通孔侧壁的EDX谱。
讨论
前面给出的结果表明,虽然在大多数情况下SiC / GaN通孔可以没有柱状缺陷[6],但是在未优化的蚀刻条件下,通孔侧壁可能是粗糙的。随着蚀刻工艺移动到更有利的蚀刻条件,除了在通孔底部没有柱状物形成之外,通孔侧壁可以基本上变得平滑。如EDX光谱分析所证实的,通孔侧壁也可以没有外来材料和副产物。然而,在实践中,在生产环境中使用SEM来监控所有晶片和所有通孔的蚀刻结果是不方便的。我们注意到,在大多数情况下,光学检查可以很容易地揭示通孔侧壁的质量,而没有太多的模糊性。如图所示,具有粗糙侧壁的通孔通常不具有与原始通孔图案一样的明确形状,而具有光滑侧壁的通孔保持其原始图案的形状
7. 如图7(a)所示,由于侧壁粗糙,圆形图案明显变形。对于侧壁光滑的过孔,底部的过孔保持完美的圆形,如图7(b)所示。
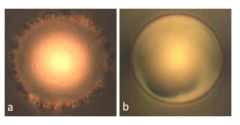
图7。SiC / GaN蚀刻后聚焦在底部的过孔的光学图像。(a)具有粗糙侧壁的过孔,以及(b)具有光滑侧壁的过孔。
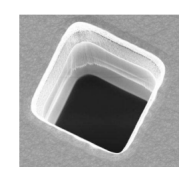
图8。纵横比为3的方形过孔的SEM图像。
图2-7是纵横比为~ 2的通孔,其中纵横比是圆形通孔的通孔深度与通孔直径之比,或者是方形或矩形通孔的通孔深度与通孔宽度之比。优化的蚀刻工艺可以很好地延伸到更高纵横比的过孔,图8是纵横比约为3的方形过孔的示例。过孔侧壁是光滑的,并且通孔的底部基本上没有柱状物形成。
结论
诸如通孔硬掩模的各种因素对通孔侧的平滑度有显著影响。已经开发了一种新的蚀刻工艺,其产生近乎完美的光滑通孔侧壁,并且对诸如通孔蚀刻掩模的其它变化不太敏感。这种蚀刻工艺已经被证明适用于SiC衬底中纵横比为3的小通孔。还示出了可以使用非常简单的光学检查作为通孔侧壁质量的第一标准,而不使用SEM检查。这大大简化了生产环境中的在线检测过程。
下一篇: 衬底通孔蚀刻和清洗