引言
湿化学蚀刻硅体微加工是制造不同类型微机械结构的关键步骤。对各种形状的三维结构有很高的需求。然而,可能获得的结构范围是有限的。限制主要来自于有限数量的适用蚀刻溶液。这种解决方案强加了蚀刻速率的各向异性,最终决定了最终蚀刻图形的形状。由于合理的(1 0 0)面刻蚀速率和令人满意的表面光洁度,有机溶液中的TMAH和无机溶液中的KOH具有最大的实际意义。
我们研究了不同醇类添加剂对氢氧化钾溶液的影响。据说醇导致硅蚀刻各向异性的改变。具有一个羟基的醇表现出与异丙醇相似的效果。它们导致(hh 1)型平面的蚀刻速率大大降低,通常在蚀刻凸形图形的侧壁处发展。这就是凸角根切减少的原因。具有一个以上羟基的醇不影响蚀刻各向异性,并导致表面光洁度变差。
实验
实验中使用了电阻率为5 ~ 10o·cm的n型(1 0 0)取向硅片。晶片覆盖有热生长的1毫米厚的氧化物,该氧化物在光刻工艺中被有意地图案化,以便限定边缘垂直于特定晶体方向的图形图案。在蚀刻过程中形成的凹凸图形使得能够对所形成的晶面进行蚀刻速率评估。我们讨论了掩模图案的布局和基于显影图形形状的蚀刻速率估计方法。图1显示了台面结构的扫描电镜俯视图,其边缘垂直于晶体方向,在80℃的氢氧化钾异丙醇溶液中蚀刻1小时。在图的边界上,可以区分出三个轮廓。最外面是蚀刻图形的底部,第二个是氧化物掩模,最后一个蚀刻图形的顶部,显示氧化物掩模底切。通过测量距离b,即(1 0 0)表面上的侧壁投影。
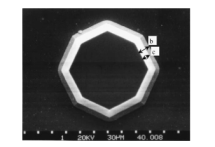
图1 台面结构的扫描电镜照片(b)和氧化物掩模下方(c)
在含酒精溶液中的蚀刻过程是在80℃的温度下进行的,在一个带有回流冷凝器的恒温容器中,允许在± 0.5 ℃内温度稳定。在每次实验中,在溶液中加入酒精混合物。表1显示了一组所应用的醇,包括它们的一些物理化学性质。

表1 氢氧化钾溶液添加剂用醇的理化性质
结果和讨论
图2示出了(1 0 0)平面的实验蚀刻速率,根据蚀刻深度估算,用精度为1毫米的测微计直接测量,在纯的、10 M KOH和5 M KOH的溶液中用不同的醇添加剂蚀刻硅晶片。除了乙二醇之外,蚀刻速率彼此差别不大。它们都非常接近1毫米/分钟。在60分钟蚀刻时间后,测量误差非常低(1毫米/60分钟),然而,差异不仅来自蚀刻深度的差异,而且来自所得表面的粗糙度。覆盖蚀刻表面的不规则小丘可能是测量规尖端没有接近真实(1 0 0)表面的原因。对于除10 M氢氧化钾和5 M氢氧化钾异丙醇之外的所有蚀刻溶液都观察到这种情况,其中蚀刻表面光洁度非常好。然而,这意味着蚀刻速率其他醇的表面可能超过测量值。

图2 不同醇添加剂的氢氧化钾溶液中(1 0 0)面的腐蚀速率
如图3所示,在10M氢氧化钾解的情况下,凸图的侧边实际上并没有与规则的侧壁有界。图3中:(1) 10 M氢氧化钾;(2) 5 M氢氧化钾丙醇-1;(3) 5 M氢氧化钾异丙醇;(4) 5 M氢氧化钾丁醇-1;(5) 5 M氢氧化钾异丁醇;(6) 5 M氢氧化钾仲丁醇;(7) 5 M氢氧化钾叔丁醇。

图3 在含有不同酒精添加剂的氢氧化钾溶液中,蚀刻速率比Vh k l/V100
可以清楚地看到,蚀刻速率比Vh k l/V100揭示了添加酒精和纯氢氧化钾溶液中完全不同的行为。对于甘油和乙二醇,估计(h k l)平面的蚀刻速率是不可能的。在甘油中,我们观察到蚀刻图形缺乏各向异性,类似于纯5 M氢氧化钾溶液中蚀刻的图形。在乙二醇中,添加剂强烈影响所有晶面,抑制它们的蚀刻速率。整个表面都被黑暗的降水覆盖着。因此,甘油和乙二醇都被忽略了。
在纯10微米氢氧化钾的情况下,(高k低)面的蚀刻速率超过(1 0 0)面的蚀刻速率。氢氧化钾溶液中的酒精添加剂导致所有考虑的(高k l)平面的蚀刻速率比Vh k l/V100显著降低。
在所有结构的情况下,除了在纯氢氧化钾中蚀刻的结构,蚀刻过程进行1小时。在所有角落,氧化物掩模的底切清晰可见。这对于在纯氢氧化钾溶液中蚀刻的结构是最明显的,尽管该过程仅持续30分钟。此外,不同的面孔试图在角落里发展。
总结
从应用的角度来看,添加到5 M氢氧化钾溶液中的含有一个以上羟基的醇添加剂并不令人感兴趣。在乙二醇的情况下,蚀刻的表面覆盖有深色沉淀,尽管它们类似于在氢氧化钾异丙醇溶液中蚀刻的图形,但产生的图形显示出明显得多的掩模底切。
典型的表面活性剂属于聚氧化物醇或烷基-苯酚聚立啶醇的醚类。然而,丙醇或丁醇基的醇也具有低表面张力,可以揭示表面活性剂和张力活性。它们可以显著增加表面的水性,这至少导致促进氢气泡脱离蚀刻表面。添加到氢氧化钾溶液中的丙醇比丁醇具有更好的表面光面度。根据[6]的结果,醇在(100)表面的吸附随着醇分子中甲基数量的增加而减少。
在氢氧化钾叔丁醇溶液中,已经观察到在减少凸角底切方面特别有利的效果。叔丁醇具有最低的表面张力,导致高折射率平面的蚀刻速率降低最多。然而,由此产生的表面覆盖着许多小丘和其他特征,恶化了其质量。表面光洁度的提高与凸角底切的减少无关,这是由于醇与具有不同键构型的晶面的不同相互作用造成的。
综上所述,我们必须承认,为了控制蚀刻过程,对氢氧化钾溶液的添加剂进行精心选择仍然需要广泛的研究。在高浓度溶液中发生的相互作用很难理解。在这种情况下,物理和化学性质都会发生变化。唯一的信息可以从宏观效应的观察中获得。研究中使用的醇通过降低一些高折射率平面的蚀刻速率改变了蚀刻特性。我们分析了一些可能影响这种行为的特性。这些考虑应该有助于选择氢氧化钾溶液的其他添加剂。
从应用的角度来看,一些醇变得非常有趣,特别是用于制造包含凸角的微机械器件。在氢氧化钾叔丁醇溶液中蚀刻的结构几乎理想地成像了蚀刻台面的形状。不幸的是,蚀刻表面覆盖着无数小丘状结构。然而,没有小丘的区域使我们希望蚀刻工艺的一些改变(氢氧化钾和叔丁醇的浓度、温度、搅拌)将导致表面光洁度的提高。
上一篇: 晶圆键合单晶硅槽波导和环形谐振器
下一篇: InP 激光器中光栅的化学清洗