评估各种清洗技术的典型方法是在晶片表面沉积氮化硅(Si,N4)颗粒,然后通过所需的清洗工艺处理晶片。国家半导体技术路线图规定了从硅片上去除颗粒百分比的标准挑战,该挑战基于添加到硅片上的“> 1000个氮化物颗粒”。然而,它没有规定用于Si,N4颗粒的沉积技术。用于在硅测试晶片上沉积Si,N的两种常用方法是气溶胶沉积技术或湿浸沉积技术。迄今为止,文献中还没有报道过这两种Si3*4沉积方法之间的比较,以确定这些方法是否产生相同的颗粒去除挑战。本文比较了这两种沉积技术。我们发现了两种沉积方法的优点和缺点。颗粒沉积的优选方法取决于具体的应用。
实验结果
可以使用湿法沉积技术涂覆整个晶片舟,因此舟内所有晶片上的颗粒计数比一次涂覆一个晶片的气溶胶沉积技术更加一致。参见图2所示的方框图。

图二。添加的Si、N颗粒数量对颗粒沉积技术的箱线图。
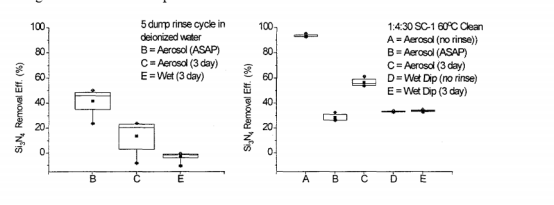
图3。颗粒去除的箱线图图4。水洗步骤后颗粒去除效率的箱线图。60°c下1:4:30 SC-1清洁后的效率。
结论
硅的粘附性;对于湿法沉积和气溶胶沉积的颗粒,N4颗粒与硅晶片是相似的,只要通过气溶胶沉积方法制备的晶片在颗粒沉积后立即在去离子水中漂洗。每种沉积技术都有优点和缺点。如果只需要几片晶片,喷雾技术可以很快完成。该方法也在晶片表面沉积较小尺寸的Si3 *颗粒。需要进行水冲洗步骤。
如果更困难的粒子去除挑战是必需的。然而,必须控制气溶胶沉积和水冲洗步骤之间的时间,以获得一致的颗粒去除挑战。湿法沉积技术提供了一种涂覆大量晶片的方法,在每个晶片上添加大约相同数量的颗粒,并且颗粒在晶片表面上非常均匀地分布。与气溶胶沉积相比,添加到湿浸晶片中的大尺寸颗粒明显更多。湿沉积粒子的粒子去除效率的变化小于气溶胶沉积粒子的变化。对于湿法沉积方法,沉积设备的成本也较低。当选择要使用的Si,N4沉积方法时,必须考虑这些优点和缺点。