引言
发光二极管(LED)已成为近30年现代节能照明技术的基础。通过各向异性蚀刻n面氮化镓的蚀增是当今生产蓝白发光二极管(led)的关键方面。表面积和表面角度的数量都增加了,有利于光从发光二极管芯片耦合输出。通过金属有机化学气相沉积(MOCVD)生长的氮化镓叠层结构在非连续掺杂的铀-氮化镓体区发生了变化。2D和三维生长层的不同顺序导致位错密度的变化,这通过光致发光显微镜和x光衍射来监测。应用了包括激光剥离(LLO)在内的薄膜处理,在升高的温度下,在氢氧化钾水溶液中测定外延变化对N面蚀刻动力学的影响。电感耦合等离子体发射光谱(ICP-OES)被用于以小时间增量高精度测量蚀刻过程。由此,克服了诸如确定体重减轻或身高差异的其他技术的缺点,实现了高精度和可再现性。
实验
氮化镓层的制备:
标准的c面取向氮化镓外延层生长在衬底上。如图1所示,用不同的叠层制备外延叠层A-E。a在下面的讨论中作为参考样本。通常在最靠近基底的层中进行三维生长。我们选择2D生长来达到高的初始位错密度并获得最大的位错密度变化。改变三维生长条件是为了减少由位错向横向弯曲引起的缺陷。众所周知,3D生长可以通过各种生长方法来启动。样品C由3000纳米厚的单2D氮化镓层组成。d的特点是一个修正的2D-三维转变,导致更多的位错穿透2D-三维界面。在E中,制备了两个随后的2D-3D转变的阿瑟序列,这两个转变由组合厚度为2000纳米的3D和2D氮化镓层分开。a、C和E包含一个基本的MQW,以便进行位错密度的光致发光显微镜分析。
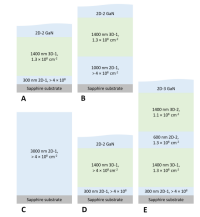
图1 外延堆栈设计A-E
薄片加工:
为了获得最大的再现性,外延晶片被分成1 × 2厘米的片。为了防止硅衬底在热氢氧化钾溶液中腐蚀,在背面沉积了一层薄铂层。使用前,通过在室温下用稀释的NH4F水溶液处理10分钟来去除LLO残留物,并在去离子水中漂洗(DIW)。
蚀刻版画:
蚀刻实验在50毫升聚丙烯中进行。使用乙二醇加热浴和红外激光温度计,精确保持温度不确定度为1.5℃。通过红外温度计和毛细管温度计的比较来评价温度测量的可信度。浸入样品前,将氢氧化钾溶液预热10分钟,以在充分预热和最小水分蒸发之间找到平衡。在室温下蚀刻的情况下,我们等待混合水和氢氧化钾后1天确保温度稳定。
结果和讨论
刻蚀动力学的电感耦合等离子体发射光谱分析:
对单一的氮化镓芯片的相同氢氧化钾稀释进行4倍分析,得到平均249±3nm的氮化镓去除,因此相对误差为1%(平均±SDM,n=4;图2)。用相同的氢氧化钾溶液测量不同的稀释度,蚀刻深度为250±3nm,也导致相对误差为1%(平均±SDM,n=3)。最后,对来自同一晶片上相邻位置的4个不同的氮化镓样品芯片进行分析,得到了246±8nm的蚀刻深度,相对误差为3%(平均±SDM,n=4)。在研究ICP-OES的重现性时,分析误差低于材料的变化。在这些方面,是通过从单个晶片上取下的样品片获得最大的重现性。因此,ICPOES方法具有足够的重现性来监测蚀刻的进展。
利用该方法,与体重减轻测定相比,我们的电感耦合等离子体发射光谱仪技术允许连续监测。一般来说,在半浓缩氢氧化钾溶液中80℃的工艺温度下,50-400纳米/分钟的蚀刻速率是可行的。在几分钟的蚀刻之后,可以形成高度高达2 m的金字塔特征,这可以导致蚀刻深度的≈400%的不确定性。
外延堆叠的变化:
采用XRD和PLM方法监测外延A-E层的位错密度(表2)。A在这里报道的实验中作为参考样本。通过将2D-1的厚度从300nm(A)增加到1000nm(B),晶体质量略有改善。

表2 通过人工计数PLM图像上5个采样区域的外延层和PL位错密度的(102)反射的XRDFWHM
外延变化对蚀刻动力学的影响:
比较了A和B在70°C和80°C下的蚀刻动力学(图4)。在每次实验开始时都观察到最快的蚀刻。这里的蚀刻速率是相当的,这是可行的,因为前300nm的材料在外延设计方面是相同的。
在B的蚀刻动力学中,在二维-三维过渡时没有观察到明显的高原形成。然而,扫描电镜分析提供了在两个样品中由于二维-三维过渡处的临时蚀刻停止而形成平面的证据(图5)。

图5 A在RT(a)在30wt%氢氧化钾溶液中蚀刻60min后的扫描电镜图像,在80°C(b)在30wt%氢氧化钾溶液中进行蚀刻2min后的B的扫描电镜图像。图像以60°的角度记录
尽管由于锥体形态的宽z振幅,选择性较低,但一些锥体显示出蚀刻平台而不是尖锐的尖端(图8a)。为了解决蚀刻停止层,E在70℃下蚀刻3分钟,以克服第一次2D-三维转换。随后样品在室温下用30重量%氢氧化钾处理5小时,这导致通过电感耦合等离子体发射光谱法测定的1161-127纳米(平均SDM,n = 3)的综合材料去除。随后的扫描电镜分析显示样品表面的几个部分中有独立的氮化镓金字塔(图8b)。由于局部不均匀性,材料的其它区域蚀刻不完全,因此降低了由ICP-OES确定的平均材料去除量(图8c,d)。在本研究过程中,无法确定在2D和三维氮化镓层界面形成平台的确切原因。、
总结
这项工作展示了两个强大的工具来增强氢氧化钾水溶液中氮面氮化镓湿化学粗糙化的可控性。首先,开发了一种电感耦合等离子体发射光谱法来监测工艺过程中的平均蚀刻深度。与重量损失测定相比,这种监测具有主要优势,因为它可以稳定地进行,而不需要由于冲洗和干燥样品而中断蚀刻过程。其次,对体氮化镓生长过程中的不同条件如何影响刻蚀速率有了更深入的了解。由于同时跨越多个外延层的大金字塔尺寸,在2D-3D转变的蚀刻动力学中没有看到平台。然而,扫描电镜显示平坦的蚀刻停止层。d和E包含2D-3D跃迁,没有显著的位错减少,也显示出平台形成。因此,转变本身导致蚀刻停止,而不是位错密度的不同。c不包含2D-三维转换,显示出与B几乎相同的蚀刻行为,而不是恒定的蚀刻速率。这证实了通过以前无与伦比的过程控制从整个氮化镓表面均匀去除材料的可能性。