摘要
研究了各种金属污染物对薄栅氧化物完整性的影响,并根据它们在结构中的最终位置进行了分类。 提出了一个简化的清洁策略,该策略具有高性能,同时具有成本效益,并且与传统的清洁序列相比对环境的影响更小。 最后,提出了一个新型的环境友好型臭氧/去离子水工艺,用于去除光刻胶和有机后蚀刻残留物。
介绍
鉴于污染对设备性能和工艺成品率的重要影响,很容易理解清洁是IC生产中最经常重复的步骤。 这些步骤消耗了大量的去离子水和化学品,从而带来了重要的生产成本,并引起了严重的环境问题。 因此,在过去的几年中,很多研究工作都致力于开发更高效、更具成本效益和更低环境影响的清洁技术。
金属污染的影响
研究了洁净室材料中常见的几种污染物(Na、Mg、Cr、Zn、Ni、V、V、Mn)或可能用于未来电介质(Ti、Sr、Ba、Pt、CO、Pb)的行为。硅晶片被清洗以获得无污染的参考亲水性表面。用pH值为=O的酸性溶液旋转,施用污染物。1含有1 ppm的被调查污染物。由于元素原子质量的变化,杂质浓度变化了一个数量级(图1)。

图1污染后的杂质浓度
污染后,4.5 nm的氧化物在干燥的0,800°C环境下生长。本研究中使用的污染物不会导致最终氧化物厚度的显著差异(图2),除了已知的Na会促进晶体SiO的形成,[ l]的形成。在大多数情况下,氧化后污染水平下降(图3)。在过渡金属的情况下,原子质量较大的元素的污染损失有较高的趋势。这可以部分解释为这些元素在硅[2]中的较高的扩散率和溶解度。钠、锌和铅在氧化过程中部分蒸发。没有观察到Mg的损失,可能是由于Mg,SiO,或MgSiO,硅酸盐[3]的形成。

图2在干燥的0中氧化后的氧化物厚度差,在800°C到标称厚度为4.5 nm
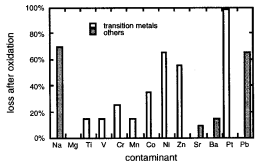
图3在干燥0中,800°C至4.5 nm的标称厚度氧化后的污染损失
结合TXRF和SIMS测量,根据元素在MOS结构中的位置对元素进行分类(表1)。由于Mn、Zn和Cr的浓度低于SIMS的检测限,因此无法进行分类。Cr对多晶硅的沉积速率有很大的影响,并且至少部分存在于多晶硅层中。
简化的清洁过程
通过使用简化的清洁策略,如IMEC-clean(表2),可以显著减少化学物质和去离子水的消耗。大多数清洗程序通常使用硫酸基混合物来去除清洗第一步的有机污染。这也可以在IMEC-clean中实现,但从环境的角度来看,在这一步中使用臭氧去离子水更可取。这是由于减少了化学物质的消耗,更重要的是,由于避免了去离子水的总量,因为硫酸浴后的困难冲洗步骤。
结论
研究了金属污染的影响。根据污染物在结构中的最终位置进行分类。结果表明,IMEC-clean可以作为常用的rca清洁剂的一种经济有效的替代品。提出了一种新型的臭氧去离子水基抗蚀剂汽提工艺。预计这一工艺可以取代集成电路生产中的大多数基于硫的工艺步骤。
下一篇: 研究多晶硅片湿法化学蚀刻响应的新技术