摘要
这段文本主要描述了APM(NHOH/H,0,/H,0)为基础的清洁混合物作为一种单一化学清洁解决方案的有趣前景。这种混合物可以去除有机污染,因为H,O具有氧化性,并且它们具有非常好的颗粒去除性能。为了优化APM清洁金属污染,需要加入络合剂(APM+M)。本文探索了APM清洁混合物作为金属去除效率的功能,即稀释比、温度和络合剂浓度的函数。对于所有金属,使用浓缩的APM溶液在高温下与金属络合剂一起使用可以获得最佳去除效果。此外,建议在APM后实施酸性漂洗,以防止在最后漂洗过程中沉积金属(如Ca)。
介绍
在过去的几十年中,化学清洗一直是保持/制作集成电路过程中保持晶片表面清洁的首选方法。RCA清洗,由Kern和Poutinen于1970年发表[1],已成为大多数前端湿清洗循环发展的基础。最初,RCA清洗由两个连续使用的清洗溶液组成。第一个清洗溶液也通常被称为SC1(或APM或NHOH/HO,/H,0混合物),用于去除有机污染物和颗粒,而第二个清洗溶液也被称为SC2(或HPM或HCVH,O/H,0混合物)去除金属污染物。在接下来的30年中,进行了许多修改和改进。
晶片清洗的未来趋势是发展更加环保和更具成本效益的清洗。最近,单晶片清洗已引起人们的兴趣,预计由于工艺集成和周期时间的考虑,这将得到更广泛的应用。优选的是,应使用单一化学物质在一步清洗中去除所有类型的污染。
当金属污染存在于APM清洗浴中时,另一个问题是金属催化的过氧化物分解。特别是Fe和Cu(程度较小)会催化H,O分解反应,从而限制了浴的使用寿命。此外,硅基底上的Fe污染会引起局部表面微粗糙。
APM 化学中金属络合剂发展的历史概述
很可能是第一次在APM清洗过程中使用络合剂是偶然发生的。事实上,在许多情况下,过氧化物用于制备APM时含有微量稳定剂,这是为了在制造和/或运输H,O时保持剩余的金属离子处于络合状态,并相应地防止其分解。这种稳定剂在某些情况下也可能在APM清洗浴中起作用。这是化学品从不同供应商获得时观察到的清洁效果差异很大的一个可能解释。
APM 基混合物的金属去除效率:一般方面
APM 清洗混合物的金属去除能力通过实验设计统计分析(Design-Expert 6.03)进行调查,使用两级因子设计确定温度、NH、OH、H0和络合剂浓度对去除Ni、Cu、Zn、Fe、Al、Ca和Cr的影响。报道了在清洗1010at/cm金属污染晶圆后表面的最终浓度。在图1中,可以看出使用APM 清洗化学物质很容易去除Ni、Cu以及较少程度的Zn。这可以通过形成可溶性氨合物来解释,而Zn在高稀释比下也会形成氧化物和氢氧化物络合物(如图2所示)。加入络合剂的结果是提高了这些金属的去除效率。
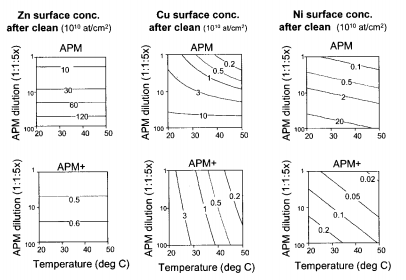
图1在不同的稀释度和温度下,在APM(上)或APM+(下)中浸泡10分钟清洗10' at/cm'金属污染晶圆片后的最终Zn(左)、Cu(中)和Ni(右)表面浓度
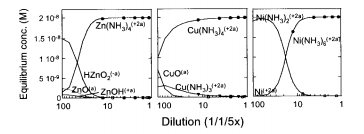
图2使用热力学软件包HSC(Outokumpu Research)计算,在20°C下,不同nhh、OH/H、0、/H、0混合比的APM清洗溶液中存在的Zn、Cu和Ni物种的平衡浓度
另一方面,Fe和Al等金属难以通过APM清洗混合物去除(如图3所示)。热力学计算表明,这些金属形成可溶的FeO和AlO或Al(OH)4。这些物种在负电荷硅晶圆表面上的强烈吸附作用令人感到惊讶,而且目前还没有完全理解。Mertens等人发现最终的Fe和Al表面浓度遵循Vt依赖关系,这表明铁和铝的沉积受扩散传输到晶圆表面的限制。一旦这些金属到达表面,它们就会立即“粘附”在表面上。Stonc等人使用核磁共振测量表明,Al可以与硅氧框架结合形成内层络合物。Morinaga等人推测,这些金属的附着是由Si的OH端基与与金属结合的OH之间的脱水反应引起的。通过在高温下使用APM+m清洗,可以显着改善这些金属的去除。如果用于拟合数据的模型扩展到设计范围之外,可以预测将温度升高至70°C导致最终铝表面污染水平为10l at/cm2。
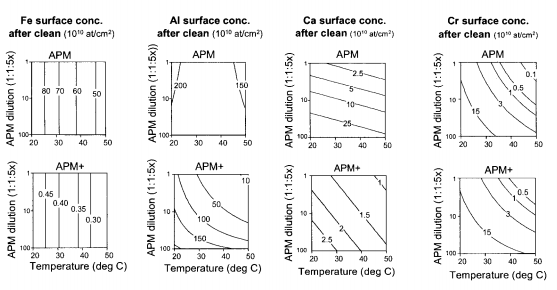
图3在不同的稀释度和温度下,使用APM(上)或APM+m(下)浸泡清洗10' at/cm'污染晶圆后,最终的Fc, Al, Ca和Cr表面浓度。
APM+w单化学清洗:单晶圆清洗的解决方案
图4显示了在70°C下进行10分钟浸泡清洁后,表面浓度对于GOl杀手金属低于5 x 10' at/cm,而对于其他金属(如Al),表面浓度低于10'" at/cm'。当清洁时间缩短为1分钟时,去除Al以及较少程度的Cr变得困难。如果使用APM+TM清洁溶液在单个晶圆清洁平台上进行清洁,这些金属的去除率甚至更低。如果在最后漂洗步骤中使用稀盐酸,则可以进一步降低Al和Cr的污染水平,但不能低于临界表面浓度(未显示数据)。为了达到更低的金属表面污染水平,需要开发对金属污染具有更高亲和力的添加剂。另一方面,还可以优化最终漂洗条件或引入短暂的稀盐酸提取步骤以去除与硅氧化物基底结合紧密的金属。
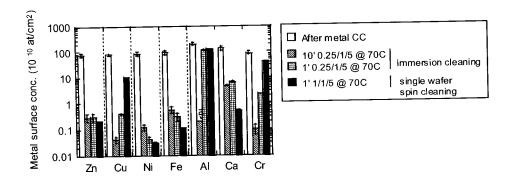
图4用10或10 /cm的金属污染晶圆片清洗10 at/cm后的最终金属表面浓度1分钟浸泡清洗或1分钟单晶圆旋转清洗,使用APM+m清洗混合物,温度为70℃。