摘要
我们开发了一种新的单片旋转清洗技术,该技术可以在室温下进行,通过喷嘴将臭氧水和稀HF溶液交替供给旋转的硅片各10秒,然后重复此循环直到表面清洁度达到所需水平。这种新的旋转清洗顺序可以有效地去除硅片表面的颗粒和金属污染物以及有机污染物,同时不会增加表面的微粗糙度。这项技术将满足更严格的晶片清洁度要求、更大直径晶片处理和更大环保要求。
介绍
在浸没式湿化学清洗中,即使引入了超纯化学品,在每个晶片清洗处理后进行处理,污染去除效率也主要取决于待清洗晶片自身带入新鲜溶液中的杂质量。为了满足未来更严格的晶片清洁要求,必须采用新的清洁方法,如单片旋转清洁,其中新鲜化学品是连续供应的。旋转加工设备比传统湿工作台的占地面积小得多,但其生产能力必须提高,化学品消耗必须降低。为了实现这一目标,必须使用具有成本效益的替代化学品而不是传统的RCA标准清洁剂,并使用更少数量的化学品,以缩短清洁时间,减少化学品消耗,从而减少清洗过程中产生的废水量。
实验
在臭氧水处理过程中,如图1所示,化学氧化膜在晶片表面迅速生长,氧化物在10秒的臭氧水应用结束时几乎达到饱和,厚度约为0.7nm。化学氧化物在10秒后几乎不再生长。因此,化学氧化物可以在随后施加的DHF中完全从晶片表面蚀刻掉。所以,20秒清洁循环和2分钟清洁循环蚀刻硅的深度没有区别。颗粒的去除被认为是是由于在臭氧水应用过程中生长在晶片表面的化学氧化物的翘起,然后通过随后的DHF处理去除。这就是为什么20秒清洁循环和2分钟清洁循环之间的颗粒去除效率没有区别的原因。需要注意的是,使用相同或更少的循环次数施加化学药品的时间过长(>10秒)并不能增加颗粒去除效率。因此,建议使用20秒清洁循环,其中包括10秒的臭氧水应用和10秒的1%DHF应用,以节省时间和化学品消耗。如果使用0.5%的DHF,建议DHF应用15秒,同时保持臭氧水应用10秒。此外,在旋转清洗过程中,从晶片表面去除的颗粒会立即被冲走,因此在通常在浸没式湿化学清洗中观察到的粒子重新沉积现象在我们的方法中并不存在,即使经过HF处理后也是如此。
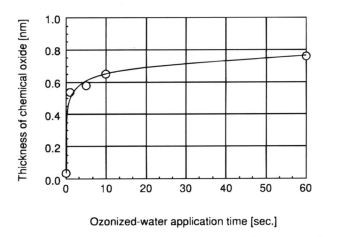
图1使用XPS测量晶片表面化学氧化物的厚度作为臭氧氧化水应用时间的函数
如图2所示,经过一个、两个和三个循环的清洁后,PSL球体分别被98%、99%和99.5%去除。因此,与Al203颗粒相比,PSL更容易从晶片表面上去除。

图1PSL粒子去除效率作为自旋清洗周期次数的函数。一个循环包括使用臭氧化水和稀释高频,每个循环10秒
金属去除-如图3所示,使用臭氧水/DHF处理仅一个循环,就将晶片表面高达1012至1013原子/平方厘米的铁和铝污染物减少到10原子/平方厘米水平或更低。

图3Fe在晶片表面前后的浓度是旋转清洁循环次数的函数
总结
使用臭氧水和DHF对单片室温旋转清洁进行了改进。旋转清洁序列包括将臭氧水和DHF交替施加到晶片表面10秒。这种短时间循环清洁可以有效地去除金属和颗粒污染物以及有机污染物,而不会增加表面微观粗糙度。可以根据需要重复该清洗循环,直到表面清洁度达到所需水平。
上一篇: 用于先进晶圆清洗的单一化学清洗解决方案
下一篇: 可转移单晶AlN纳米膜的合成及特性