介绍
为了减少晶片表面的缺陷和污染物,对后CMP清洗进行了多项研究。大多数研究都集中在化学剂输送、后CMP清洗溶液和刷洗参数对晶片表面颗粒负载和缺陷的影响上。为了满足当前的清洗要求,了解CMP残渣与PVA刷在PVA刷刷洗过程中的相互作用是很重要的。在后CMP清洗过程中,pH可以通过改变研磨剂的zeta电位和诱导刷与颗粒之间的化学相互作用来影响刷载量。因此,了解刷洗过程中的CMP残渣和清洗化学物质对于控制和防止后CMP清洗过程中缺陷的产生至关重要。
金属CMP研磨液由螯合剂、表面活性剂、研磨剂、氧化剂和其他添加剂组成。由于其球形、硬度和稳定性,胶体二氧化硅主要用作金属和氧化物CMP研磨液制备中的研磨剂。在CMP后的清洗过程中,例如PVA刷清洗,污染物通过PVA刷的机械作用被清除。晶片表面的颗粒由于与PVA刷直接接触而被PVA刷颗粒吸收,从而从基底表面清除污染物。然而,由于其高度多孔结构和亲水性,污染物会粘附到刷毛表面并在下一次清洗步骤中污染晶片。
PVA刷刷洗被认为是去除这些污染物最有效的方法。文献中已经研究了刷转速、晶片压力和摩擦力分析对刷表面二氧化硅颗粒粘附的影响[5-7]。然而,到目前为止,还没有研究过刷与颗粒之间的物理或/和化学相互作用。在我们的实验中,我们研究了在不同pH条件下胶体二氧化硅和刷之间的相互作用。首次研究了铜离子、胶体二氧化硅和刷表面之间的相互作用,重点研究了刷载量和交叉污染。
背景材料
铜的CMP后清洗过程包括酸性和碱性化学物质,用于去除研磨剂(如二氧化硅)、CMP残留物(如氧化铜颗粒)、有机残留物和垫料碎片。在清洗过程中,铜基体上的环形划痕形成是众所周知的现象,但没有研究指出划痕形成的真正原因。由于胶体二氧化硅和氧化铜颗粒与清洗液pH值变化相互作用而形成的聚集体。在铜CMP后清洗过程中形成的环形划痕,主要是由于化学输送量低、有机残留物溶解少以及残留物的疏水性导致晶圆和刷子直接接触。为了防止颗粒和划痕的形成,采用了基于碱性和酸性清洗液的多种清洗化学品。这些缺陷可以通过减少CMP后残留物或选择适当的清洗溶液来控制。然而,开发一种刷调节溶液以防止颗粒负载和控制交叉污染可以克服CMP后清洗的这些缺陷。
实验
在图1中描述了在不同的pH条件下进行浸泡实验以研究刷的污染程度。这个实验使用了浓度为20 wt%、粒径为100 nm的胶体二氧化硅,。通过浸泡实验研究了刷和胶体二氧化硅颗粒之间的相互作用。在浸泡实验中,将商业200毫米PVA刷(AION Co. Ltd.,日本)的刷结节约3毫米,随后浸泡在稀释至0.1 wt%的胶体二氧化硅悬浮液中,在三种pH条件(3、7和11)下进行。浸泡后的样品用去离子水冲洗,并在50℃的真空烘箱中干燥24小时。为了观察铜离子对刷载量的影响,将刷样品浸泡在标准铜离子溶液(ICP-MS标准溶液)中,溶液中铜离子浓度变化范围为10-100 ppm,同时添加0.1 wt%的胶体二氧化硅溶液,在不同pH条件下进行。研究了在不同pH条件下,铜离子浓度为100 ppm时在PVA刷中的吸附情况。用去离子水冲洗样品以观察PVA刷中吸收的铜量。通过场发射扫描电子显微镜(FE-SEM,S4700,Hitachi)观察了刷节点的形貌和污染程度。使用Zeta电位和粒径分析仪测量了在不同pH条件下颗粒尺寸和静电相互作用的变化。使用电感耦合等离子体-原子发射光谱(ICP-AES,Spectro Arcos)分析法估计了铜离子的浓度(以ppm计)。
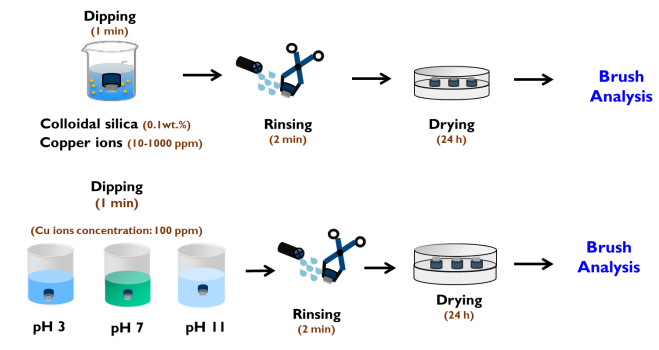
图1 用浸渍法测定电刷污染的实验方法
讨论
评估了不同pH条件下胶体二氧化硅悬浮液的粒径分布,以确认其稳定性。如图2(a)所示,在不同pH条件下,悬浮液的平均粒径为140±5 nm,且没有颗粒团聚现象。因此,所有悬浮液在所有pH条件下均表现出稳定性。如图2(b)所示,胶体二氧化硅悬浮液的Zeta电位值均为负值。与相同pH下PVA刷的Zeta电位值相比,当pH大于7时,颗粒之间的净相互作用力为斥力。随着pH的增加,胶体二氧化硅与刷表面之间的斥力也增加,我们发现刷载量最小,如图3的FE-SEM图像所示。然而,在pH为3时,我们观察到高刷载量,这可以通过刷与二氧化硅颗粒之间的静电吸引作用来解释。胶体二氧化硅的等电点在2-3之间;在此pH值下,二氧化硅表面上存在更多的羟基。这些基团也可以与刷表面形成氢键,从而增加刷载量。
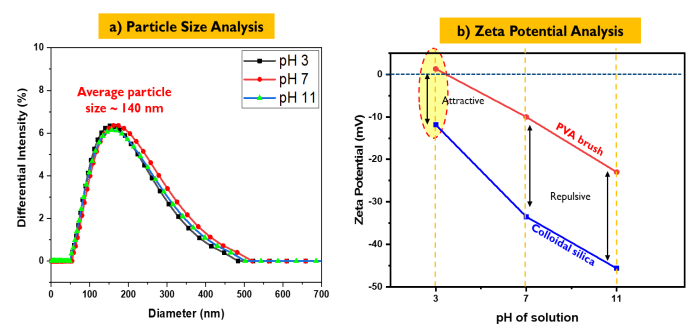
图2 (a)不同pH条件下硅浆和PVA刷在不同pH (b) Zeta电位下的粒径分布
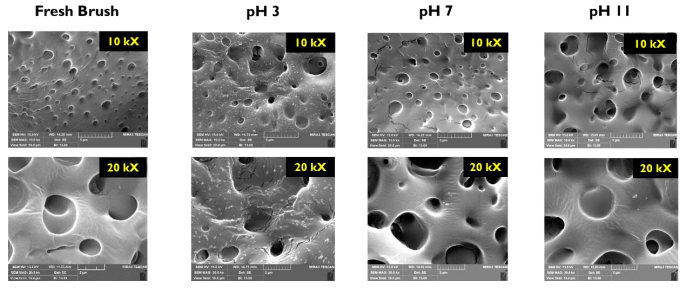
图3 不同pH条件下的PVA刷
结论
我们的研究讨论了二氧化硅和铜离子之间的相互作用及其对PVA刷载量的影响,采用了FE-SEM、zeta电位、DLS分析和ICP-AES。仅在二氧化硅存在下,pH为3时的刷载量比其他pH条件下要高。悬浮液中铜离子的存在也会影响刷载量。随着铜离子浓度的增加,刷载量也显著增加。研究表明,在没有磨料的情况下也可以形成颗粒。在pH>7时,铜离子可以进入PVA刷中。因此,为了防止在铜后CMP清洗过程中出现高刷载量,必须了解铜离子、二氧化硅和刷表面之间的化学相互作用。
下一篇: 扇出晶圆级封装铜柱最高厚度光刻胶的研究