摘要
等离子蚀刻过程的均匀性和晶圆间的重复性通常与等离子蚀刻室壁的条件有关。在先进的互补金属氧化物半导体制造中,使用了大量的金属,这些金属可能在蚀刻过程中沉积在室壁上。由于这些金属并不总是容易去除,因此可能会出现工艺不稳定。这是因为室壁上的原子种类的重组在一定程度上决定了等离子的组成。因此,本文研究了金属蚀刻残留物,特别是钛和钽残留物,对等离子组成和均匀性的影响。通过所谓的浮动样品的X射线光电子能谱分析来分析室壁,并通过光学发射光谱监测Cl2、HBr、O2和SF6等离子体中Cl、Br、O和F的密度。通过测量300mm硅晶圆的蚀刻速率来检查等离子的均匀性。发现氯和溴在金属上的重组概率与在阳极氧化铝上相似。然而,氟和氧的重组受到金属残留物的强烈影响。因此,对于氟和氧基等离子体,金属残留物显示对等离子均匀性有影响。
一、介绍
为了制造最先进的互补金属氧化物半导体器件,需要开发高精度的蚀刻工艺。需要蚀刻的结构尺寸小于几十纳米,而对300mm晶圆上数百万个特征的蚀刻目标线宽偏差的容忍度仅为几纳米。此外,涉及器件制造的不同材料数量正在稳步增长。这需要增加蚀刻步骤并增加一般蚀刻工艺的复杂性。已经证明对蚀刻工艺的可重复性产生巨大影响的一个参数是蚀刻室壁的组成。尤其是对于低压力(5-80mTorr)、高密度感应耦合等离子体(电子密度>1011cm−3)的蚀刻应用,这一现象可以通过等离子体中的原子物种可以与室壁上的物质重组成为分子来解释。重组可能是非常有效的,以至于它成为某些等离子体物种的更大损失机制,从而对等离子体中的总体物种密度产生重大影响。此外,除了总体物种密度外,等离子体中蚀刻物种的均匀性也可能受到影响。当然,对于大型基板(例如300mmSi晶圆),室壁上的蚀刻物种的重组会导致晶圆上的非均匀性。
在过去,已经研究了硅和碳基壁对等离子蚀刻的影响。为了获得可重复的等离子蚀刻条件,需要实施策略来从墙壁上除去硅或碳,或者对腔体进行条件处理,以使其能够提供可重复的结果。例如,可以使用虚拟晶圆进行蚀刻,使腔体处于最佳状态- 磨合,每个处理过的晶圆后可以点燃清洁等离子体- 无晶圆自动清洁 ,或者甚至可以在每个基片蚀刻之前在腔体中应用涂层。然而,如今,随着新材料的引入,主要是金属,除了硅或碳外,还可以形成更多种类的沉积物。这些沉积物每种都需要特殊的清洁化学品或策略5 ,因此评估金属沉积物(如钛或钽)对不同蚀刻等离子的影响是很重要的。特别关注的是钽沉积物,因为稳定的钽氧化物不能在标准无晶圆自动清洁工艺(SF6 /O2)中从腔体壁上移除。因此,钽沉积物是影响蚀刻室可重复性最容易的物质之一。已使用清洁和预先污染的腔壁用于O2、SF6、Cl2和HBr等离子体,并通过监测O、F、Cl和Br的密度研究了墙壁对重组过程的影响。这允许估算每个物种在金属沉积物上的重组系数。特别是对于氟和氧,这些数据在文献中是缺失的,本文提供了这些数据。此外,还提供了实验结果,表明重组过程对300mm基片上蚀刻速率均匀性的影响。
二、实验
实验在感应耦合等离子体蚀刻反应器中进行,该反应器设计用于蚀刻300mm基板。等离子体由13.56 MHz的平面螺旋线圈激发,线圈通过石英窗与等离子体室分离。晶圆通过静电吸附到卡盘上,卡盘可以单独供电以加速离子到基板。此卡盘还允许晶圆进行氦气冷却,以便在等离子体处理期间保持在大约60°C。腔壁由阳极氧化铝制成,并在所有实验期间保持在60°C。反应器中暴露的氧化铝表面的总面积与石英器皿表面的比例大致为3/2。
在每次实验之前,通过Joubert等人开发的所谓的浮动样品技术分析腔壁的确切组成。在腔体清洁过程或腔体壁污染物溅射过程中,将一小块Si晶片(2×2 cm²)粘贴在整块晶片上,间距约为5mm,使其与该晶片电绝缘。由于它与晶片隔离,它只受到低能离子的轰击。等离子体电位为10-15V,因此轰击浮动样品的离子能量最大为15eV,不像轰击晶片本身的离子能量那样高达数百eV。浮动块处于浮动电位,在这个意义上或多或少地表现得像接地腔壁。因此,这个浮动硅片上的沉积物被认为代表了腔壁上的沉积物。该浮动硅片具有约3nm厚的Al2O3顶涂层,该涂层通过将铝层在硅晶片上进行等离子氧化制备而成。
腔体涂层期间的刻蚀速率约为:硅300nm/min、TiN和TaN薄膜120nm/min。获得“清洁”反应器的工艺条件如下:无偏置功率;源rf功率:1000W;压力:65mTorr;气体流量:SF6 200 SCCM/O2 40 SCCM;时间:40s。在这种情况下,使用涂有Al2O3涂层的Si晶片作为晶片,并在卡盘上安装一个浮动晶片块以分析清洁条件。在Ta污染后,使用不同的清洁等离子体对腔体进行清洁——基于BCl3的等离子体,因为实验和文献8表明,Ta不能通过标准的SF6/O2等离子体进行有效清洁。在BCl3基清洁之后,再次点燃SF6/O2等离子体,使等离子体腔处于清洁状态。
三、结果
结果分为三部分。首先,展示了清洁和预污染壁的XPS测量结果,并讨论了腔壁成分对物种密度的影响。这些数据基于归一化的光学发射光谱测量。最后,展示了腔壁成分对SF6基和O2基等离子体的均匀性的影响。
1、等离子体室中污染物的沉积和表征
在任何基板的蚀刻过程中,蚀刻副产物都会沉积在反应器中,如果没有适当的清洁策略,这些沉积物会影响随后的蚀刻过程。为了模拟实验中这些副产物的沉积,使用Cl2/HBr/O2等离子体对晶片进行高偏置功率蚀刻。根据沉积在晶片上的薄膜,将不同的材料分别散布在蚀刻腔中。确切的配方在第二部分给出,但尝试通过分别蚀刻硅、钛和钽的氮化物薄膜来沉积硅、钛和钽残留物。每次一个带有Al2O3涂层的Si晶片块“漂浮”在晶片上,之后分析这个晶片块通过XPS。图1分别显示了未经等离子体处理的晶片块、经过SF6/O2等离子体清洁的腔体、SiO2涂层腔体、Ti污染和Ta污染腔体的XPS结果。
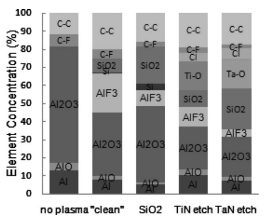
图1 反映不同处理后蚀刻室壁状况的浮动晶片的XPS分析。
由于XPS分析是在外部进行的,每个样品上都存在少量氟碳污染。这种污染不是来自蚀刻腔内的,因此在讨论腔壁成分时可以忽略。浮动样品块被证明由顶部的Al2O3涂层和底部的Al膜组成。接下来,清洁腔条件似乎由SiO2和AlF3的混合物组成。在腔内进行任何处理之前,壁材料是SiO2(石英顶板)和阳极氧化铝。然而,在连续使用SF6/O2等离子体进行清洁后,阳极氧化铝被转化为AlF3。在我们的实验中,使用SF6/O2等离子体处理时,SiO2和AlF从腔壁沉积到晶片块上。即使在SF6/O2等离子体中,AlF也可以从壁中释放到等离子体中,并最终沉积在浮动块上。因此,该块上的AlF3不仅来自Al2O3块的氟化,而且该块确实代表了等离子体处理期间的腔壁实际状况。这也是通过在腔内沉积SiO2的样本证实的。除了在浮动块上检测到的大量SiO2(因为从带电晶片溅射的Si),还检测到了AlF,这意味着再次从壁中释放的AlF被沉积在浮动样品上。对于最后两个样本(Ti和Ta),可以观察到,在TiN或TaN蚀刻期间,金属残留物确实沉积在蚀刻腔内。再次使用XPS检测到SiO2和AlF,因为这些材料在清洁后存在于腔壁上,并在蚀刻过程中沉积在浮动块上。XPS结果表明,对于金属污染,壁实际上由Si和金属氧化物的混合物以及AlF3组成。
2、腔室壁对物种密度的影响
通过OES测量腔壁材料对物种密度的影响。实验在不同的压力下进行,但目的不是比较不同压力下的结果,因为随着压力的变化,等离子体的电子温度也会变化,从而导致OES结果的不确定性。因此,数据反映了蚀刻腔壁变化时物种密度的差异。图2显示了Cl2和HBr等离子体中Cl和Br密度的结果。

图2 (a)不同蚀刻腔壁条件下的相对Cl 808 nm强度;(b)不同蚀刻腔壁条件下的相对Br 834 nm强度。
3、腔壁对等离子体均匀性的影响
蚀刻率在平坦晶圆上的均匀性是离子流到达晶圆的均匀性和中性粒子到达晶圆的均匀性之间的相互作用。本部分选择的实验是为了只显示中性流到达晶圆的均匀性,因此在两个实验中都设定了射频偏置功率为零。由于在本工作中测试的金属沉积对Cl和Br密度的影响较小,因此只研究了SF6基和O2基等离子体中腔壁污染对均匀性的影响。设置了两组实验:第一组实验测量了SF6等离子体中硅的蚀刻率均匀性,第二组实验测量了O2等离子体中光刻胶的横向蚀刻率(修剪率)的均匀性。在这两种情况下,均一性都与清洁腔和Ta污染腔进行了比较。
图4显示了清洁和Ta污染的蚀刻腔中SF6等离子体中非晶硅的蚀刻率。
Ta污染腔中的蚀刻速率整体较高,这表明等离子体中氟化物物种的含量较高。此外,从图4中可以清楚地看到腔壁对等离子体均匀性的影响。在清洁腔中,蚀刻速率在中心较高(中心高蚀刻速率),而对于Ta污染腔,观察到中心蚀刻速率较低。令人惊讶的是,两种实验的整体均匀性大致相同。

图4 在SF6等离子体中硅的蚀刻率均匀性;a图为在清洁蚀刻腔中进行的实验;b图为在Ta污染腔中进行的实验;工艺条件:线圈功率300 W,压力5 mT,10 SCCM SF6稀释后加入He;使用5 s的CH2F2等离子体来穿透自然氧化层。
图5显示了80纳米光刻胶线在O2等离子体中的横向蚀刻或修剪结果,分别在清洁和Ta污染的腔中进行。

图5 80纳米光刻胶线在O2等离子体中的修剪率均匀性;a图为在清洁蚀刻腔中进行的实验;b图为在Ta污染腔中进行的实验;工艺条件:线圈功率300 W,压力30 mT,10 SCCM O2稀释后加入He。
清洁腔中的整体修剪速率要高得多。两种情况下,都观察到中心修剪速率较高,但清洁腔条件下的均匀性更好。
四、结论
本文研究了腔壁成分对蚀刻率均匀性的影响。特别关注金属污染对等离子体均匀性的影响,因为一些金属,如钽氧化物,不容易通过标准清洁工艺从腔壁上去除。一般来说,具有较低复合概率的反应器壁将产生最均匀的中性分布。对于氯和溴,在钛和钽氧化物上的复合概率与阳极氧化铝相似。对于氟和氧,我们分别观察到金属氧化物上的复合概率较低和较高。因此,金属蚀刻残留物会影响氟和氧基等离子体的蚀刻率均匀性。