摘要
本文介绍了一种单晶片、全硅、高纵横比多层多晶硅微加工技术,该技术将硅的深度干法刻蚀与常规表面微加工相结合,以实现几十到几百微米厚、高纵横比、具有亚微米气隙的电隔离多晶硅结构。在该技术中可以实现与主体多晶硅结构一样高的垂直多晶硅感测电极。使用该技术已经制造了一个70毫米高、2.5毫米宽的多晶硅振动环形陀螺仪,其具有1.2毫米的电容气隙和与环形结构一样高的电极。还制作了高220毫米、纵横比为100:1的垂直多晶硅梁。这种技术的全硅特性提高了长期稳定性和温度灵敏度,而具有亚微米间隙间隔的大面积垂直拾取电极的制造将把微机电系统器件的灵敏度提高几个数量级。这种技术也能够在同一硅衬底上同时产生电隔离的二维平面和三维垂直多晶硅结构。
介绍
本文介绍了一种新颖的单晶片、高纵横比多层多晶硅微加工技术,该技术将硅的深度干法刻蚀与传统的表面微加工技术相结合,以实现几十微米厚、非常高纵横比、具有高品质因数和均匀材料特性的电隔离多晶硅结构。在该技术中可以实现与主体结构一样高的多晶硅电极。使用牺牲氧化物层可以形成亚微米电容间隙。这两个因素一起将显著增加检测电容,从而提高器件灵敏度。此外,该技术能够同时产生二维平面和三维垂直。
制造技术 略
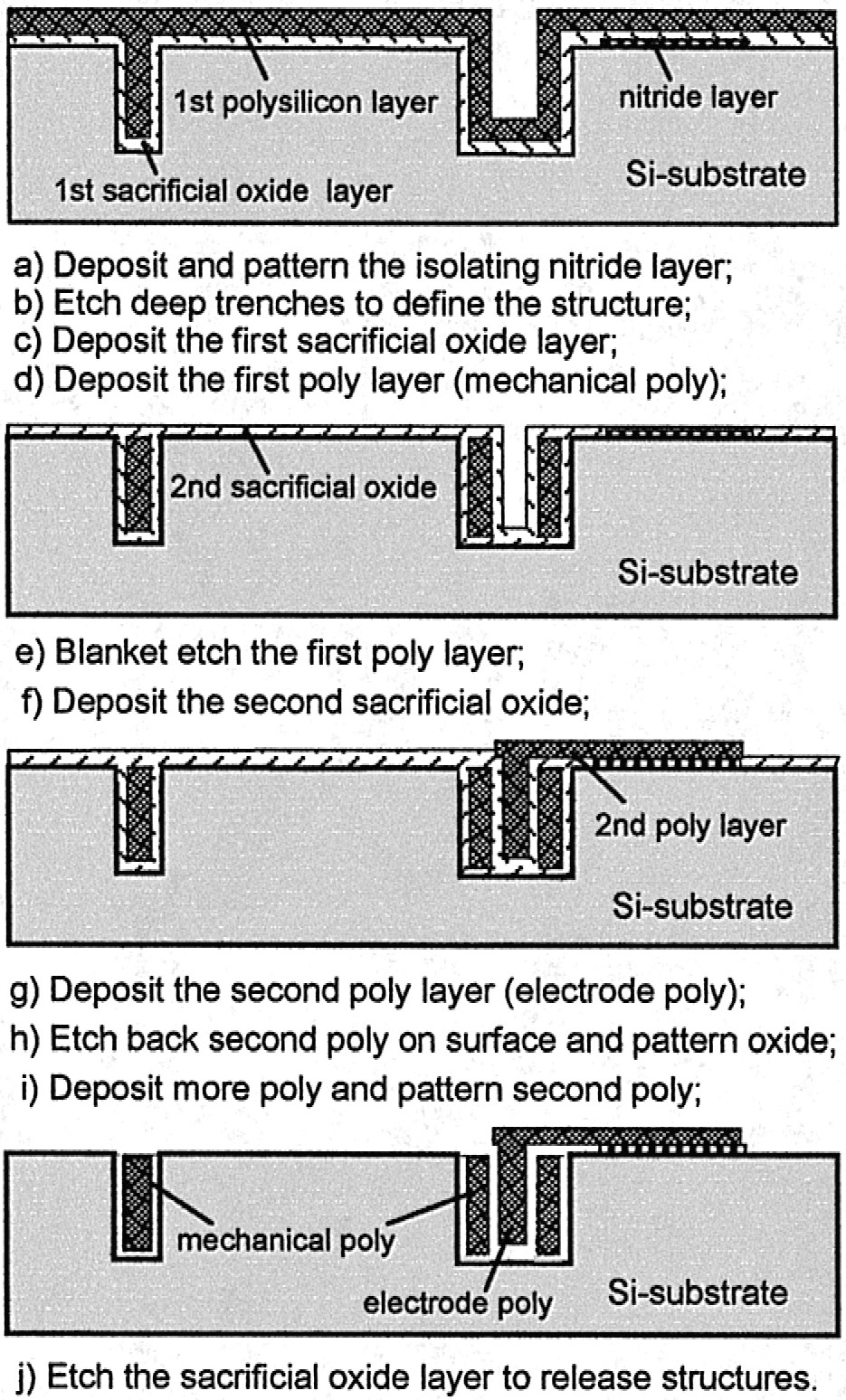
图1.高纵横比多晶硅微加工技术的制造工艺流程
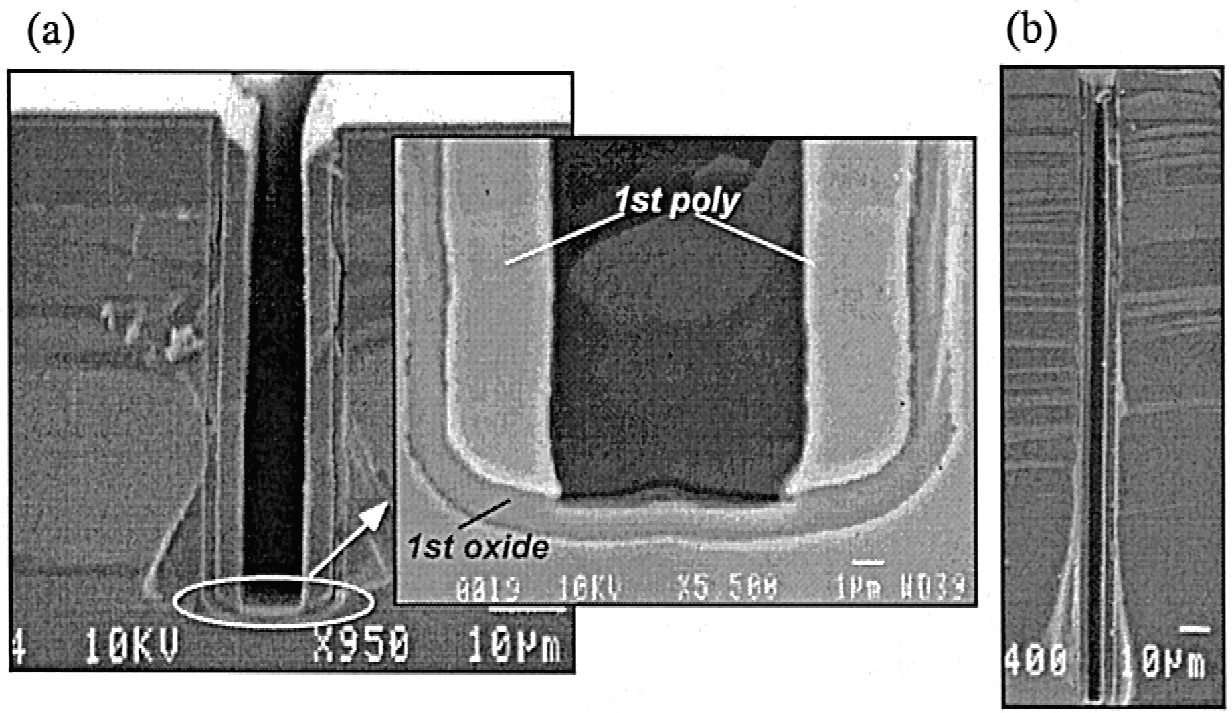
图2 a通过定向的基于氯的RIE蚀刻,在70毫米深的沟槽底部完全蚀刻3毫米厚的多晶硅;b .在220毫米深的沟槽底部蚀刻2.2毫米厚的多晶硅,而不蚀刻侧壁,从而产生纵横比为100:1的多晶硅束
制造结果
该技术已被用于制造许多微机电系统结构,包括厚多晶硅振动环形陀螺仪,其多晶硅感测电极与环形结构一样高以感测环形振动。感测电极先前是使用pqq硅岛制成的,因此它们的高度被限制在2×2 -15 mm,导致更小的检测电容。
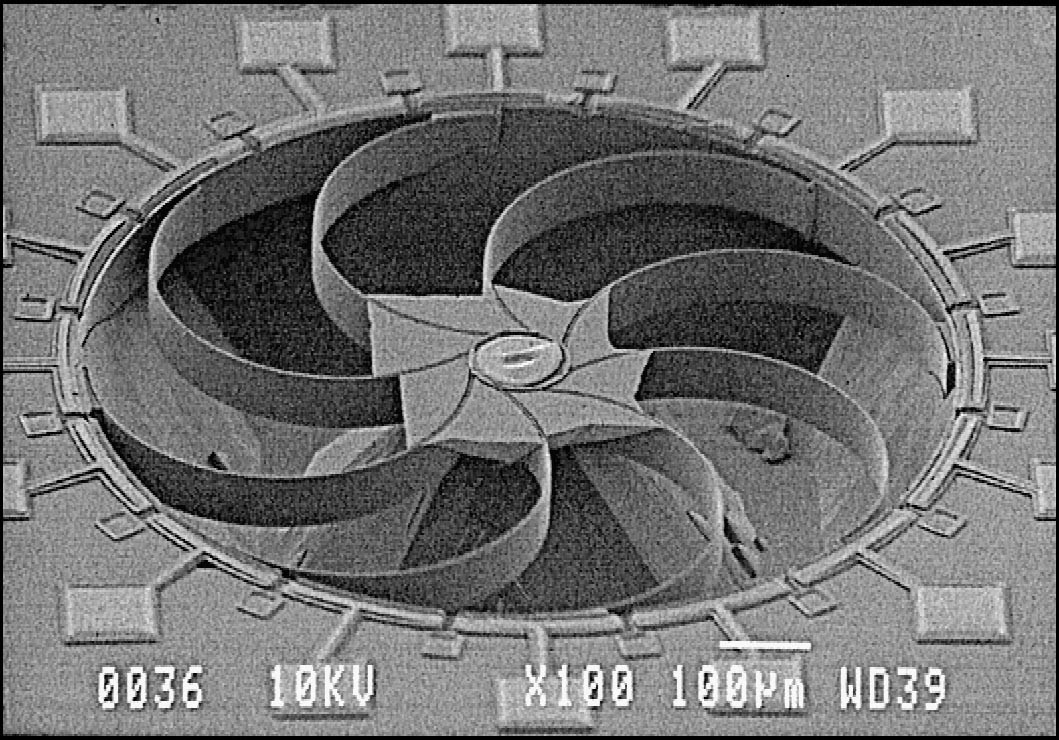
图3通过高纵横比多晶硅微加工技术制造的多晶硅环形陀螺仪的扫描电镜图。硅已经溶解在电子数据处理中,以显示高纵横比的环和弹簧
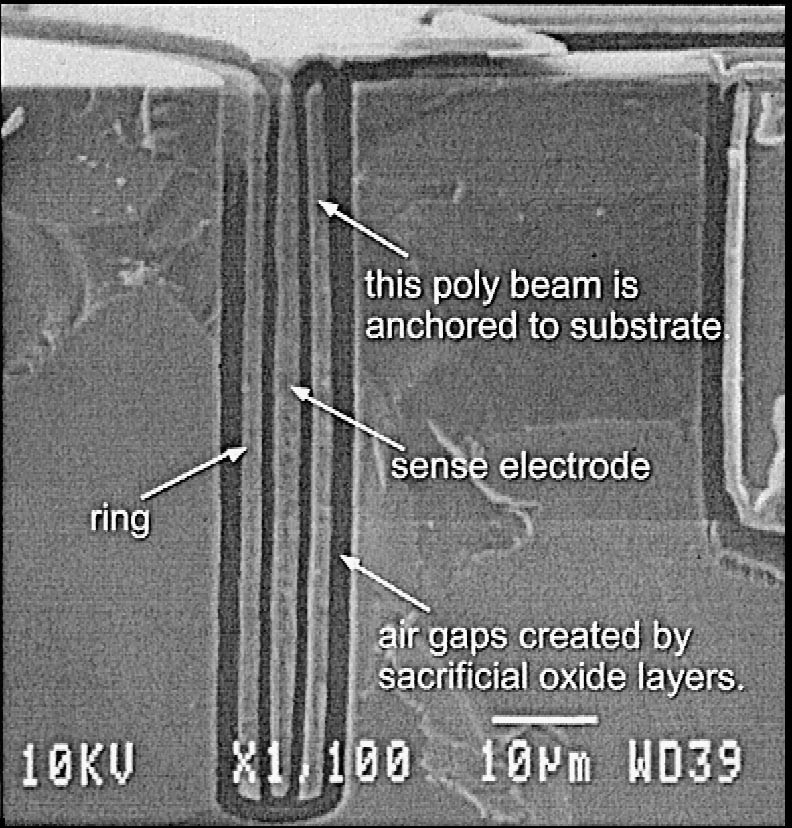
图4 由均匀气隙隔开的70毫米高多晶硅环和传感电极的截面图
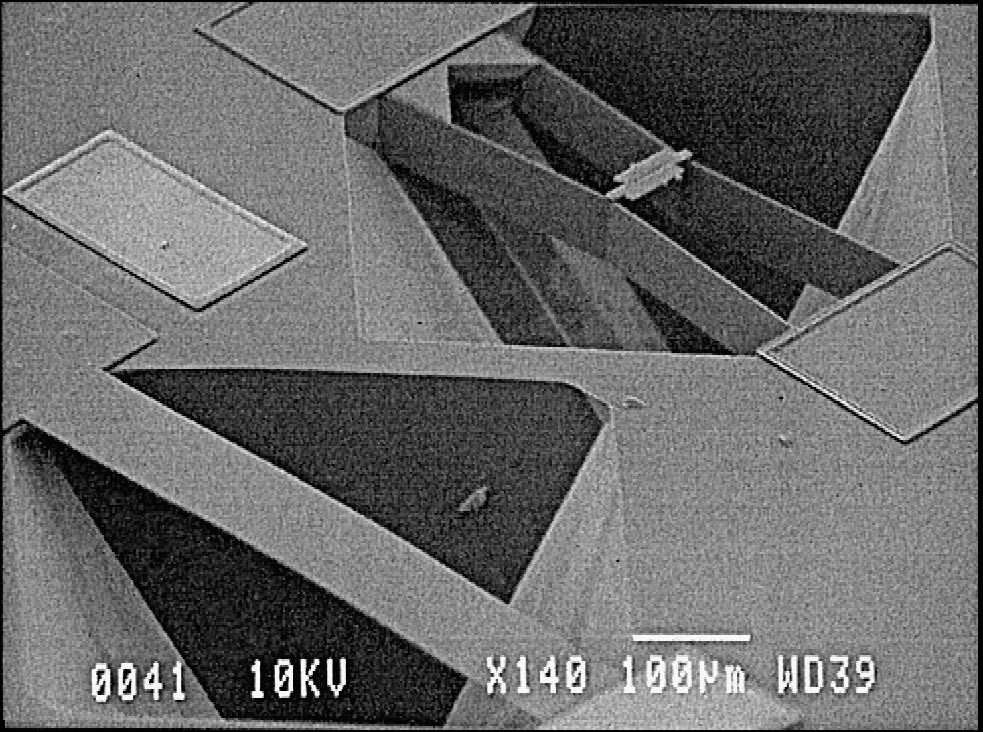
图5 使用这种技术在同一衬底上制造的三维和平面结构可以电连接或机械连接或隔离
结论
本文报道了一种单晶片、全硅高纵横比多层多晶硅微加工技术,该技术可以实现高纵横比、几十到几百微米厚、电隔离的三维多晶硅结构,该结构具有使用牺牲氧化膜形成的亚微米气隙。在这种多晶硅微加工技术中,可以实现与主体多晶硅结构一样高的电绝缘垂直多晶硅电极。已经制造了具有100∶1纵横比的220毫米高的垂直多晶硅梁。这种技术的全硅特性提高了长期稳定性和温度灵敏度,而具有亚微米间隙间隔的大面积垂直拾取电极的制造将把微机电系统器件的灵敏度提高几个数量级。
上一篇: 光电化学湿蚀刻
下一篇: 铜在去离子水中的蚀刻