摘要
本研究提出了一种通过顶向(top-down)方法,结合等离子体蚀刻和室温氢氧化钾(KOH)湿处理工艺,实现具有所需m-(甚至a-)取向非极性面的GaN柱的策略。事实上,GaN在KOH溶液中的蚀刻是一个各向异性过程,这意味着它允许在宏观尺度上出现稳定的面,而原子过程(如步流)在微观尺度上驱动湿蚀刻的基本机制。本研究强调了形状(圆形或六边形,与m-平面或a-平面对齐)和硬掩模粗糙度在确定晶体面形成及其相关粗糙度方面的关键作用。此外,它强调了等离子体图案化后GaN柱的形状(倒锥形、直筒形或锥形)对后续湿蚀刻机制的影响。最终,该文章证明,通过在等离子体蚀刻后使用略微倾斜的GaN轮廓,结合使用六边形m-取向硬掩模,可以在室温下使用44 wt%的KOH溶液实现平滑的m-取向面。
介绍
核心-壳层结构为解决目前平面III-N LED在紫外线(UV)范围内效率低下的问题提供了一种有前途的策略。这种方法涉及制造高度有序的高纵横比(AR > 10)GaN纳米线阵列,并在其上沿径向生长发射量子阱(QW)。通常,采用AlGaN势垒/GaN QW结构来实现UV-A至UV-B发射(400-280 nm)。核心-壳层结构具有多个优点,包括减少发射层中的晶体缺陷、通过在GaN非极性晶体面上生长来提高内部量子效率(量子限制斯塔克效应)、增加发射表面积和增强光提取。大多数关于用于UV发射的GaN纳米线的研究都是基于分子束外延(MBE)或金属有机气相外延(MOVPE)的底向上方法进行的。然而,使用这些方法控制纳米线的尺寸和密度仍然具有挑战性,同时生长直径小于1微米的纳米线也是一个挑战。
在用氢氧化钾(KOH)湿溶液蚀刻GaN的情况下,蚀刻机制是基于通过羟基(OH-)分子氧化镓原子,羟基分子攻击并打破Ga-N键,从而使镓原子氧化成Ga2O3,随后溶解在溶液中。平面的蚀刻能力强烈取决于平面密度和氮原子上的负电荷悬挂键的数量,这些悬挂键排斥OH- 。平面的EBI值越高,该平面的蚀刻越困难。基于EBI指数,半极性平面({11-2k}和{1-10k},其中k > 0)比非极性平面({11-20} a-平面族和{1-100} m-平面族)和比Ga(0001)c极性平面蚀刻得更快。与半极性平面相比,非极性平面的稳定性增加,这为在仔细控制湿KOH条件时揭示所需的m-面提供了可能性。
实验装置
2.1. 样品制备
微柱的制造是4英寸晶片上进行的,该晶片采用无掺杂的Ga极性(0001)GaN制成,厚度为4微米,在c-蓝宝石衬底上生长。根据数据表规格,穿插位错密度小于5.108 cm-2。通过等离子体增强化学气相沉积(PECVD)技术,使用四乙氧基硅烷(TEOS)等离子体增强化学蒸汽沉积(PECVD),将800 nm厚的二氧化硅硬掩膜沉积在氮化镓层上。
然后,样品在45°C的超声浴中用丙酮清洗5分钟,用异丙醇冲洗3分钟,并用氮气流干燥。随后,使用以下参数在样品上旋涂一层800纳米厚的电子敏感抗蚀剂(maN 2410):加速:3500 rpm/s,速度:2000 rpm,时间60秒。最后,将样品放置在90°C的热板上进行抗蚀剂固化处理,持续90秒。
随后,使用JBX-6300FS系统进行电子束光刻(EBL),加速电压为100 kV,电流为1 nA,曝光剂量为600 µC/cm²。通过将样品浸入MF26A显影剂中90秒,随后再浸入MF26A和去离子水(体积比1:9)的混合液中30秒,完成抗蚀剂的开发。然后将样品在去离子水中冲洗8分钟。经过所有这些步骤后得到的堆叠结构如图1-a所示。
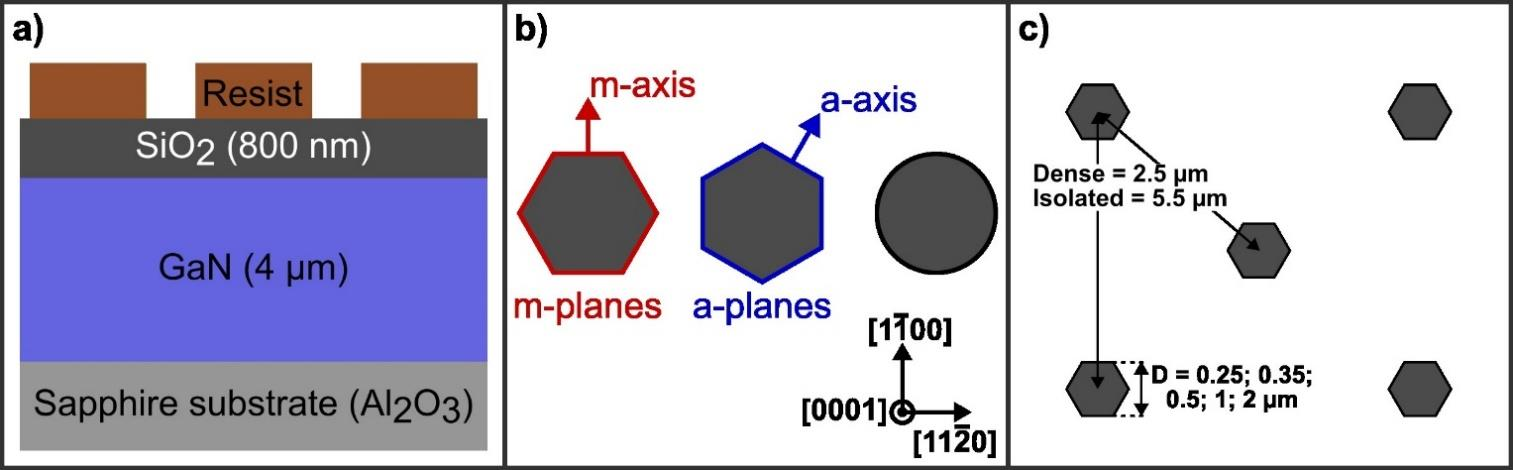
图1. a) 所使用的堆叠示意图,b) 光刻点的形状,六方排列的a-或m-面GaN或圆形。c) 点阵的交错排列,标注了点直径和它们之间的距离。
2.2.等离子体和湿法过程
蚀刻实验5200蚀刻平台上进行,该平台由三个等离子体反应器组成,专为200毫米晶片设计。
3.湿KOH结果
氢氧化钾实验在25 mTorr的氯气等离子体中进行氮化镓蚀刻。在这些等离子体条件下,柱形轮廓几乎是各向异性的,顶部下方1微米处有一个轻微的凸起(如图2-a)。正如我们在之前的研究中所解释的,这个凸起对应于由SiN连续波和GaN蚀刻副产物再沉积形成的Si基钝化层。在柱的顶部,该钝化层的厚度约为25纳米,在顶部下方1微米的深度处达到最大厚度55纳米(在凸起区域)。然后逐渐变薄并在柱的底部消失。经过BOE处理(用于去除硬掩模)后,该钝化层被去除,导致GaN柱呈现近乎完美的各向异性(如图2-d)。正如我们在之前的研究中所讨论的,观察到经过Cl2等离子体蚀刻后的GaN柱呈现出沿非极性a平面的面(参见图2-d),无论硬掩模的形状如何。

图2. 在25 mTorr的Cl2等离子体下,使用m-取向的硬掩模和KOH湿法操作后,直径为0.5微米的GaN柱的扫描电子显微镜图像。a)是等离子体蚀刻后的图像,d)是没有硬掩模的柱形轮廓。d)是经过等离子体蚀刻和BOE去除硬掩模后的柱形轮廓。
然后将含和不含HM的氮化镓样品浸入氢氧化钾溶液中:
没有硬掩模的柱的上部发生侵蚀,随着KOH处理时间的增加,这种退化逐渐垂直和水平扩展,形成粗糙的阶梯状轮廓(如图2-e和2-f)。
另一方面,构成柱侧壁的a型非极性平面表现出显著的稳定性,即使在长时间KOH暴露下也保持相对未蚀刻(如图2-f)。GaN的蚀刻机制似乎发生在c-水平平面和非极性垂直平面之间的交界处,沿垂直和水平方向传播。值得注意的是,柱顶部的损伤导致m-面的出现,而与初始的硬掩模形状无关(如图3)。
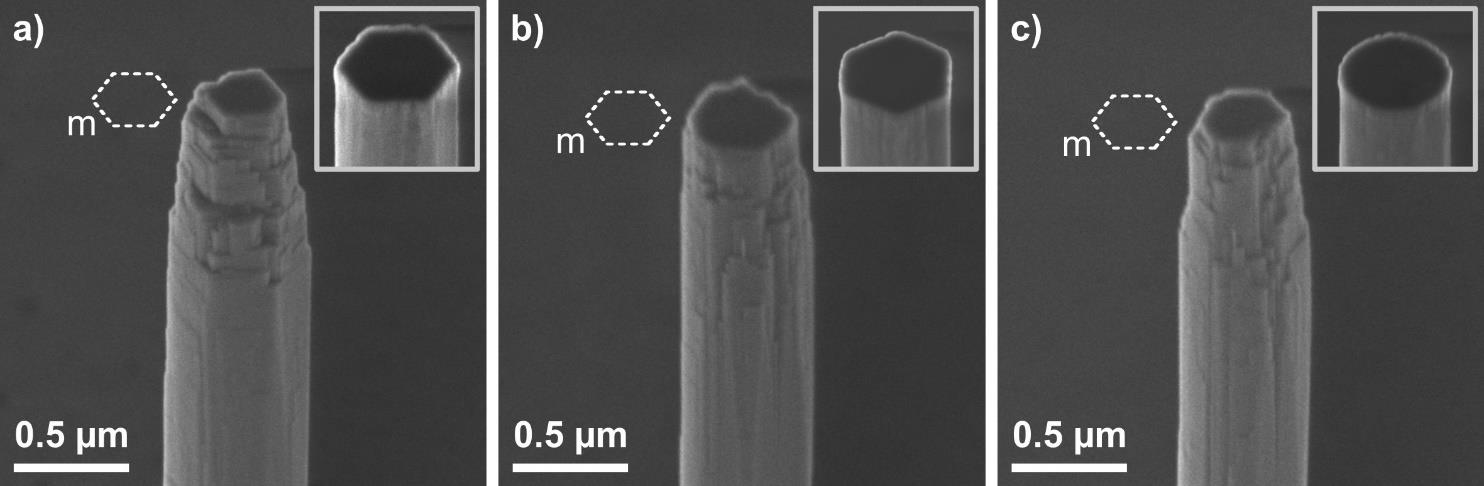
图3. 在KOH处理3小时后,无硬掩模(用BOE去除)的0.5微米直径的GaN柱的扫描电子显微镜图像。在BOE之前,硬掩模的形状为:a) m-取向,b) a-取向,c) 圆形。右上角带框的图像对应于KOH处理之前柱的形状。
4.讨论
如果没有硬掩模存在,柱顶部的自由c Ga极性平面作为根据EBI因子的蚀刻停止面。然而,GaN柱的顶部边缘在之前的等离子体蚀刻步骤中受到了损伤,暴露出一些更容易受到湿法蚀刻影响的弯曲部位。这些部位的去除很快导致c-水平面和a/m垂直面上形成台阶。这些台阶沿c-平面水平传播,沿a/m平面垂直传播,这一机制被称为弯曲传播。每个创建的台阶边缘变得脆弱,导致与最稳定平面对齐的台阶的形成(如图4-a)。在我们的情况下,这些是最稳定的平面c和m平面,解释了图2-e、2-f和图3中观察到的阶梯状粗糙度。这种传播机制如图5-b和图5-e所示。
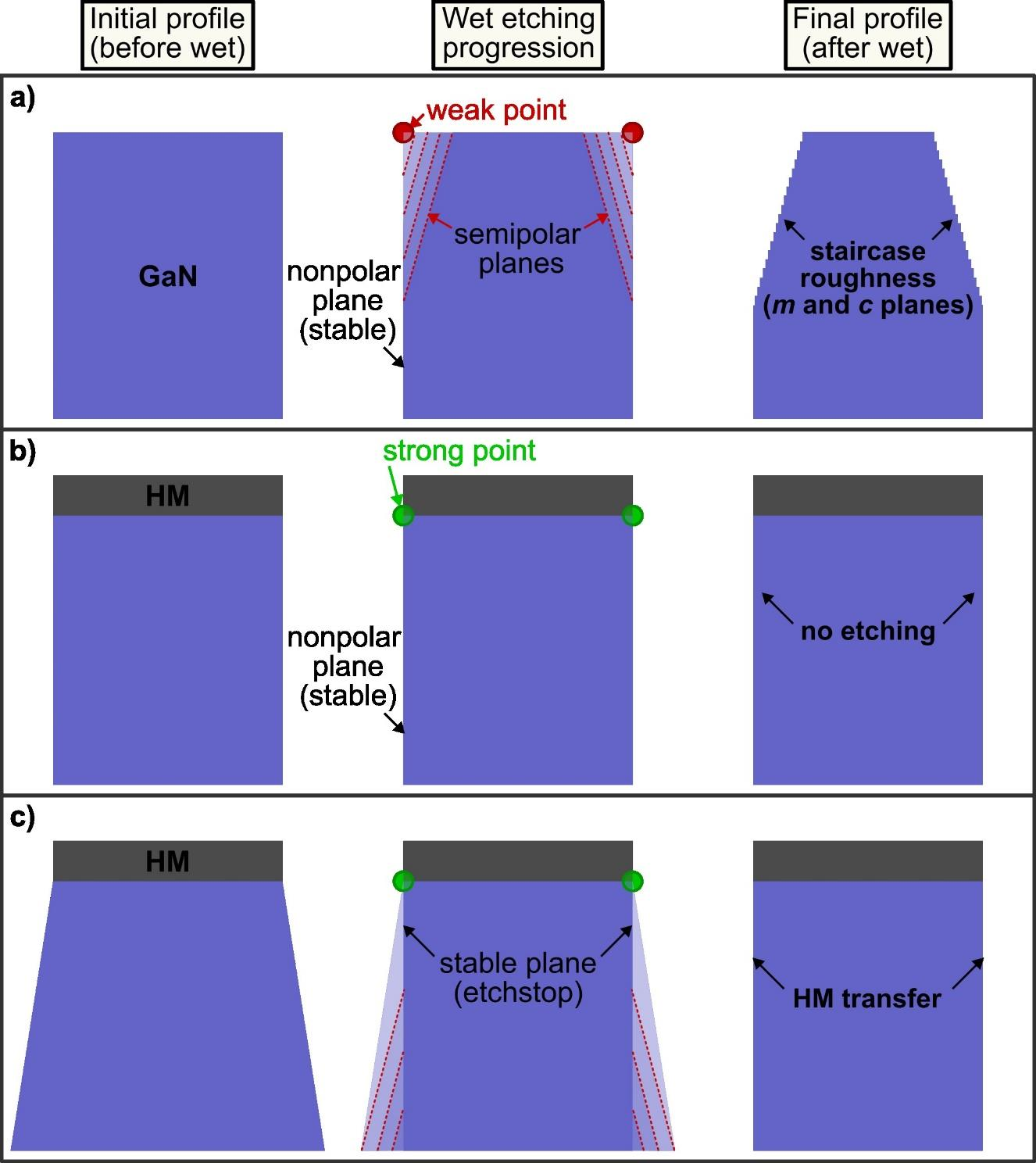
图4.对于a)无HM的柱,b)有HM和直线轮廓的柱,c)有HM和锥形轮廓的柱,湿氢氧化钾期间氮化镓轮廓演变示意图。红色虚线表示湿法蚀刻的进展。
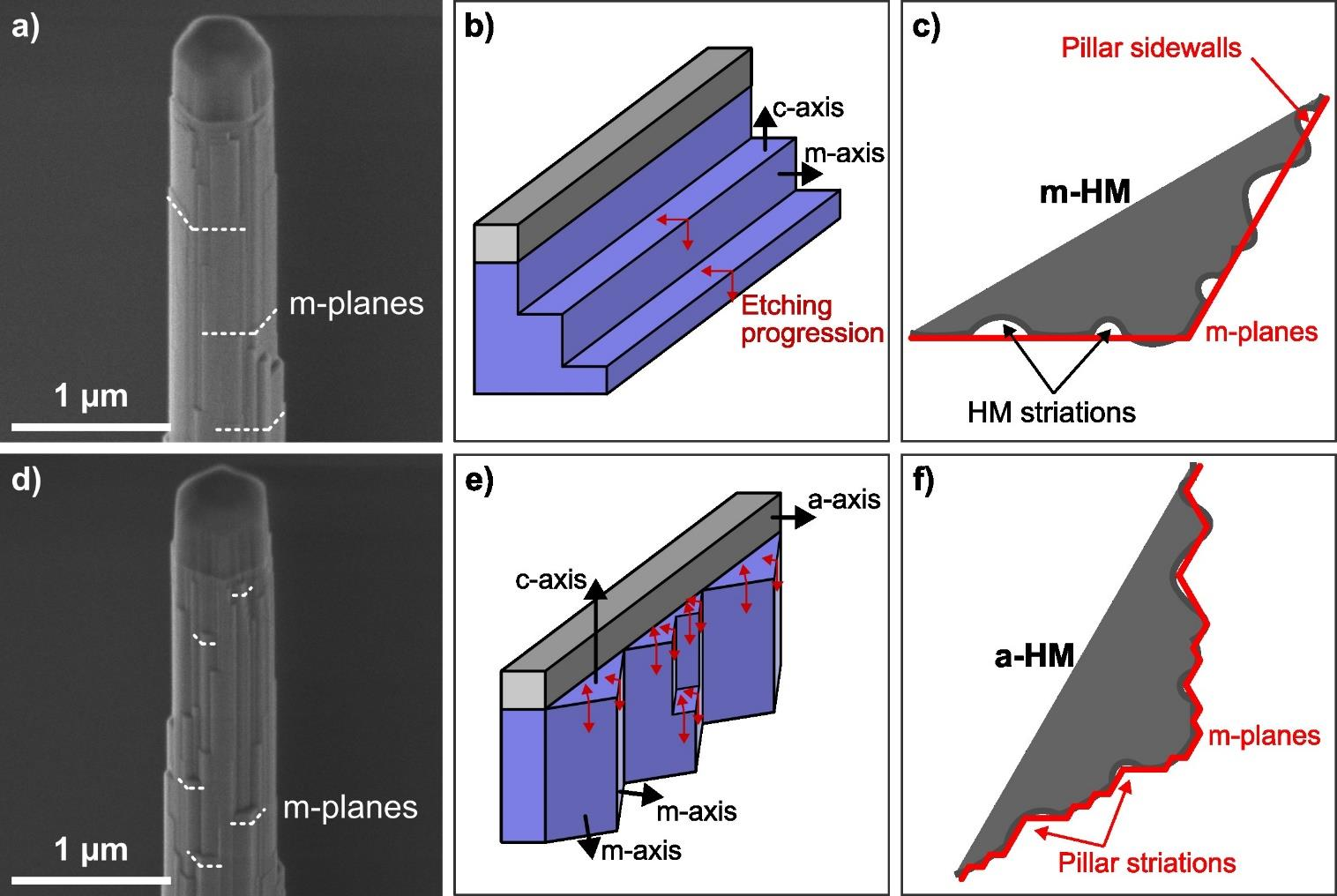
图5. a),d)氢氧化钾和氢氧化钾硬掩模部分刻蚀(15 mTorr,6小时氢氧化钾)后柱子的扫描电镜图像。b),e)示意图分别说明了氢氧化钾和氢氧化钾硬掩模情况下的面的形成和蚀刻传播。红色的箭头表示阶梯式边缘的传播。c),f)示意图分别说明了m向和a向硬掩模情况下的硬掩模条纹对柱侧壁的影响
5.结论
我们的研究提供了通过结合Cl2等离子体蚀刻和KOH湿法工艺的顶层方法来获得具有所需m-(或甚至a-)定向非极性面的各向异性GaN柱的策略。我们的研究揭示了三个主要因素可能影响湿法刻蚀后的GaN柱形貌。首先,在湿法过程中,硬掩模的存在可以防止柱顶部的退化,并允许硬掩模的尺寸和形状的各向异性转移。其次,等离子体蚀刻后的GaN柱形貌驱动后续的KOH湿法刻蚀机制。事实上,我们的研究表明,垂直的m和非极性平面以及水平的c平面在室温下对KOH具有化学惰性,如果没有出现折痕位点。相反,倾斜的半极性平面被刻蚀,并且刻蚀沿着半极性平面的法线传播,同时显示出m型和c型面。因此,如果湿法刻蚀之前,GaN柱具有与硬掩模边缘对齐的平滑垂直非极性平面表面,则柱不会被KOH刻蚀。然而,如果存在斜坡,与a型半极性平面相对应的锥形侧壁将迅速被湿KOH刻蚀。刻蚀沿着半极性平面的法线进行,同时显示出c型和m型稳定面。半极性平面迅速转化为{1-100}和{0001}台阶的集合,这是最稳定的平面。一旦由于硬掩模的存在而无法再进行侧向扩展刻蚀,刻蚀就会停止。
基于这些观察,如果想要获得具有光滑m定向侧面的GaN柱,可以通过结合Cl2蚀刻后略微倾斜的GaN形貌,使用六角形m定向硬掩模,然后进行44%湿KOH处理(在我们的情况下为6小时)来实现。类似的方法可用于获得a定向的GaN柱,但在这种情况下,侧面的面将由粗糙的垂直棱柱形条纹组成,其中包含m平面。因此,为了获得具有光滑a定向侧面的GaN柱,我们建议将a定向的六角形硬掩模转移到GaN层中,并使用Cl2等离子体蚀刻工艺(例如,在我们的研究中,使用25 mTorr的条件导致各向异性GaN形貌)。在硬掩模和钝化层被移除后,可以获得具有光滑a定向侧面的各向异性GaN柱,如我们之前的研究所示。
上一篇: 2D MXene 电化学晶体管
下一篇: 用硝酸和氢氟酸刻蚀硅的研究