摘要:本文提出了一种数字蚀刻方法,以实现对蚀刻深度的精确控制。该方法使用HNO3氧化和BOE氧化物去除工艺的组合,对p+ Si和Si0.7Ge0.3的数字蚀刻特性进行了研究。实验表明,由于低激活能,氧化会随着时间的推移而饱和。提出了一种物理模型,用于描述用硝酸进行的湿氧化过程。该模型通过实验数据进行了校准,并获得了氧化饱和时间、最终氧化物厚度以及Si0.7Ge0.3与p+ Si之间的选择性。还研究了叠层Si0.7Ge0.3/p+ Si的数字蚀刻。发现由两个Si层之间的SiGe层刻蚀形成的隧道深度与数字蚀刻周期成比例。氧化也会饱和,每周期的相对饱和蚀刻量(REPC)为0.5 nm(4个单层)。提出了一个修正的选择性计算公式。该氧化模型也通过Si0.7Ge0.3/p+ Si堆栈进行了校准,模型的选择性与修正公式相同。该模型还可以用于分析工艺变化和重复性。它可以作为实验设计的指导。选择性和重复性应该进行权衡。
1.介绍
在这项工作中,我们研究了使用HNO3氧化和BOE去除工艺在p+ Si和Si0.7Ge0.3平面表面上的Si/SiGe数字蚀刻特性。我们发现Si0.7Ge0.3和p+ Si在HNO3中的氧化饱和以及饱和时间。我们提出并校准了一个用于氧化过程的物理模型。接着,我们对叠层p+ Si/Si0.7Ge0.3进行了蚀刻研究,并与我们的氧化模型进行了校准。我们使用修正的方法计算了选择性。平面和叠层结构之间的蚀刻特性存在差异。
2.SiGe选择性数字蚀刻方法
图1显示了使用HNA测量的Si0.7Ge0.3选择性刻蚀形貌的SEM图像。HNA能够获得非常高的选择性。然而,刻蚀形貌是不均匀的,因为HNA系统对位错密度和划线缺陷很敏感。隧道中的不良界面与外延缺陷或应变有关。而在边缘,界面相对较平滑,因为缺陷移动到了外表面。同时,Si0.7Ge0.3与p+ Si之间的相对刻蚀速率较大,为2.5~4 nm/s。HNA大的刻蚀速率和时间刻蚀特性使其难以精确控制隧道深度。因此,HNA可能不是在小器件中选择性刻蚀SiGe的好方法。
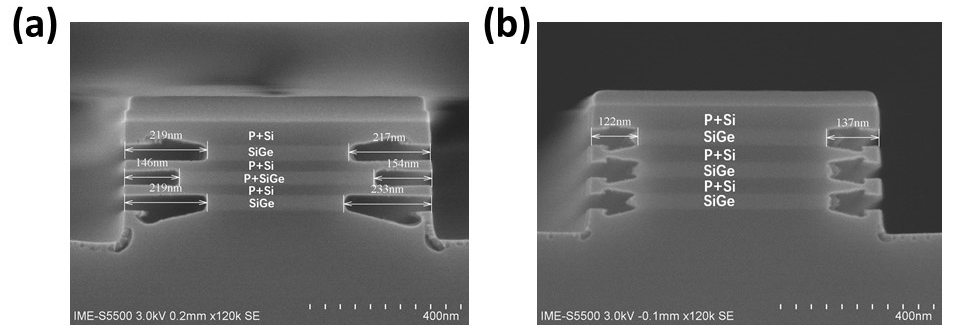
图1。HNA处理后层压Si/Si0.7Ge0.3的扫描电镜图像。(a)蚀刻时间为60秒。(b)蚀刻时间为30秒。HF(48%)/硝酸(70%)/水的体积比为10 ml: 784 ml: 716 ml。
选择性数字蚀刻方法基于原子层沉积(ALE)概念和HNA氧化-刻蚀理论。HNO3将Si/SiGe氧化成氧化物,然后使用HF或BOE去除氧化物。该方法最初被提出用于选择性蚀刻SiGe,具有精确控制和良好的重复性。通过调整不同的氧化时间,我们可以获得不同的选择性。此外,与HNA刻蚀相比,数字蚀刻形成的隧道没有缺陷坑。
3.实验
实验使用了三种类型的结构。起始基板是8英寸的p型掺杂(100)体硅片,然后在H2气氛下,在650℃和20 Torr的条件下,使用低压化学气相沉积(RPCVD)进行外延生长Si和/或SiGe薄膜。SiH2Cl2(DCS)和GeH4是SiGe层的挥发性前驱体,而SiH4是Si层的前驱体。图2a是60 nm的本征Si0.7Ge0.3,图2b是110 nm的重掺杂硼硅,浓度为1E20 cm-3,插入Si0.7Ge0.3以与Si基底区分,图2c是40 nm的本征Si0.7Ge0.3和40 nm的p+ Si交替生长三个周期。图2a中的平片Si0.7Ge0.3样本和平片重掺杂硼硅(p+ Si)样本(图2b)用于测量平片Si0.7Ge0.3和平片p+ Si的每周期蚀刻量(EPC);图2c中的层压Si/SiGe用于测量相对每周期蚀刻量(REPC)和蚀刻选择性。EPC是通过总蚀刻量除以总蚀刻周期数来获得的,而REPC是通过相对总蚀刻量,即隧道深度,除以总蚀刻周期数来获得的。流程图如图2d所示。在实验之前,所有样品都浸入BOE中3分钟以去除自然氧化层。每个实验包含60个周期,以减小自然氧化层厚度和测量误差的影响。
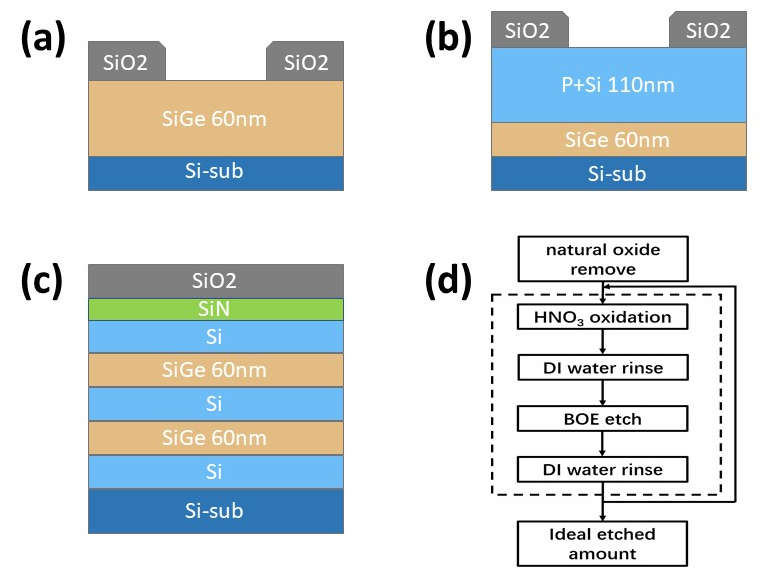
图2.我们实验中使用的样品结构示意图,(a)平Si0.7Ge0.3、(b)平p+ Si和(c)层压Si0.7Ge0.3/ p+ Si样品。二氧化硅和氮化硅堆栈是硬掩模。(d)HNO3/BOE数字蚀刻流程图
将HNO3溶液用去离子水稀释,体积相同(2.5 L)。通过改变HNO3(70%)和去离子水的体积比,来调整HNO3的浓度。由于HNO3溶液容易挥发,设置了监控样品以确保实验的稳定性。取I号样品1-30个循环,II号样品31-60个循环,III号样品整体1-60个循环,发现60个循环样品的隧道深度是30个循环样品的两倍,而两个30个循环的样品相同。这种方法还可以证明隧道的深度与蚀刻周期成正比。
所有样品都用去离子水稀释50倍的BOE进行蚀刻,总BOE体积保持为2 L。当HF浓度过高时,Si或SiGe会受到损伤。在我们的实验中,蚀刻时间为1分钟。
4.结果与讨论
4.1.Si0.7Ge0.3和p+ Si样品
我们首先探索了HNO3-BOE对平片Si0.7Ge0.3和平片p+ Si薄膜的选择性数字蚀刻特性。蚀刻速率用每周期蚀刻量(EPC)表示,蚀刻周期数为60。暴露的Si0.7Ge0.3的蚀刻厚度是通过SiO2下的厚度减去蚀刻后暴露的Si0.7Ge0.3的剩余厚度来计算的,同样适用于平片p+ Si。经过80秒氧化60个周期数字蚀刻后的平片Si0.7Ge0.3的SEM图像如图3所示。
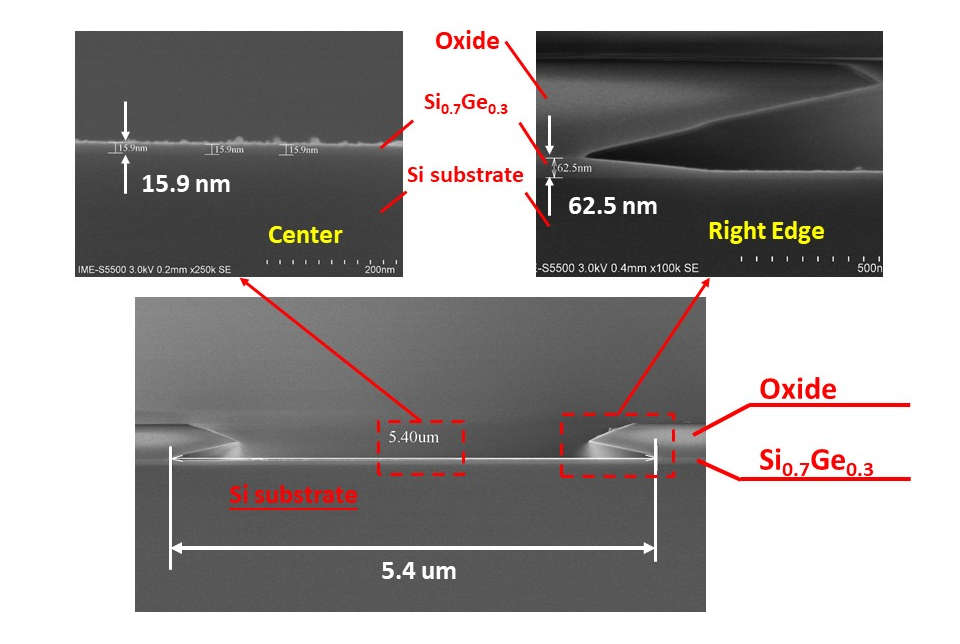
图3.经过80秒氧化60个周期数字蚀刻后的平片Si0.7Ge0.3的SEM图像。插图是测量沟槽中心和右侧平面的放大图。蚀刻的Si0.7Ge0.3深度是氧化物下厚度与暴露的Si0.7Ge0.3剩余厚度的差值。
随着氧化时间的延长,Si0.7Ge0.3和p+ Si都被蚀刻。在25%的HNO3中,Si0.7Ge0.3的饱和时间和蚀刻速率为60秒,0.76 nm/周期,而p+ Si的饱和时间和蚀刻速率为120秒,0.45 nm/周期,如图4所示。
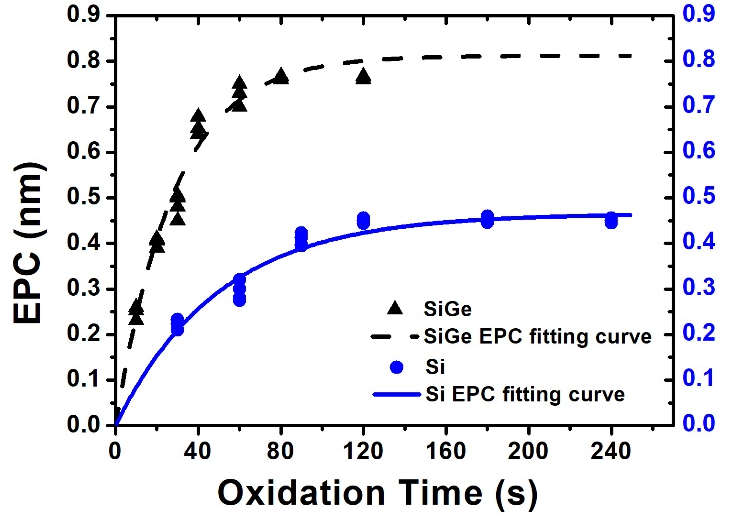
图4.在25%的HNO3浓度和60个蚀刻周期的数字蚀刻中,Si0.7Ge0.3和p+ Si的每周期蚀刻量(EPC)作为氧化时间的函数。三角形和虚线来自我们通过方程3为Si0.7Ge0.3进行实验和建模的结果。圆圈和实线来自通过方程4为p+ Si进行实验和建模的结果。
4.2.Si0.7Ge0.3和p+硅层压结构
使用25%的HNO3,氧化时间分别为10秒、30秒、60秒、90秒和120秒时,样品的截面在图5中展示。与HNA相比,HNO3-BOE数字蚀刻的形态更好,假设氧化不像蚀刻那样对缺陷敏感,氧化会在短时间内达到饱和,而BOE蚀刻时间不够长,无法通过缺陷蚀刻Si。因此,对于小型器件和异质结来说,HNO3-BOE数字蚀刻比HNA蚀刻系统具有优势。从图5可以看出,当氧化时间超过30秒时,隧道深度几乎保持不变,当氧化时间超过60秒时,垂直Si蚀刻深度(即Si损失)保持不变。值得注意的是,当氧化时间少于10秒时,隧道深度明显减小,蚀刻表面粗糙。这可能是由于SiGe/Si的氧化预老化时间和氧化初期表面更快的氧化速率。
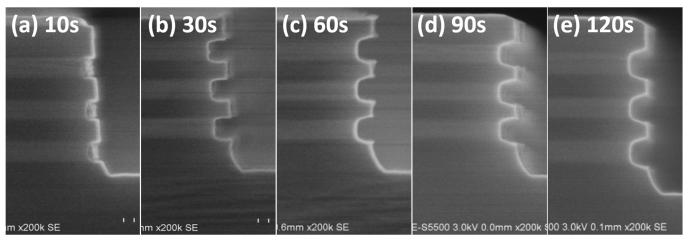
图5.在25%硝酸下进行60次数字腐蚀循环后的扫描电镜图像: (a) 10 s、(b) 30 s、(c) 60 s、(d) 90 s和(e) 120 s。由于我们的外延工艺,Si0.7Ge0.3层上界面质量比下界面差11,Si损失包括缺陷的去除。结果表明,上硅损失大于下硅损失。为了验证数字蚀刻是一个表面反应,用EELS进行的元素分析如图6所示。样品-1为原始样品,浸入25%硝酸中24 h后,用BOE蚀刻5 min,样品-2为25%硝酸氧化时间后30 s的数字蚀刻。EELS分析表明,样品-1没有明显的相对蚀刻,碳、氧等元素只存在于表面,在SiGe内部没有发现氧原子。最重要的是,氧化12只发生在表面,并随着时间的增加而饱和。同时,从HRTEM可以忽略样品2 Si损失,证明了较大的选择性。
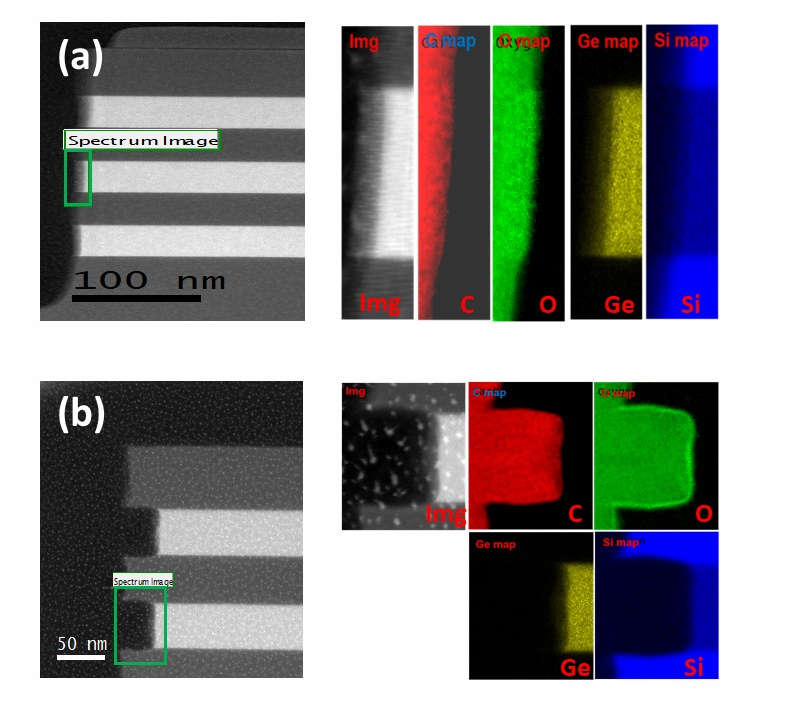
图7
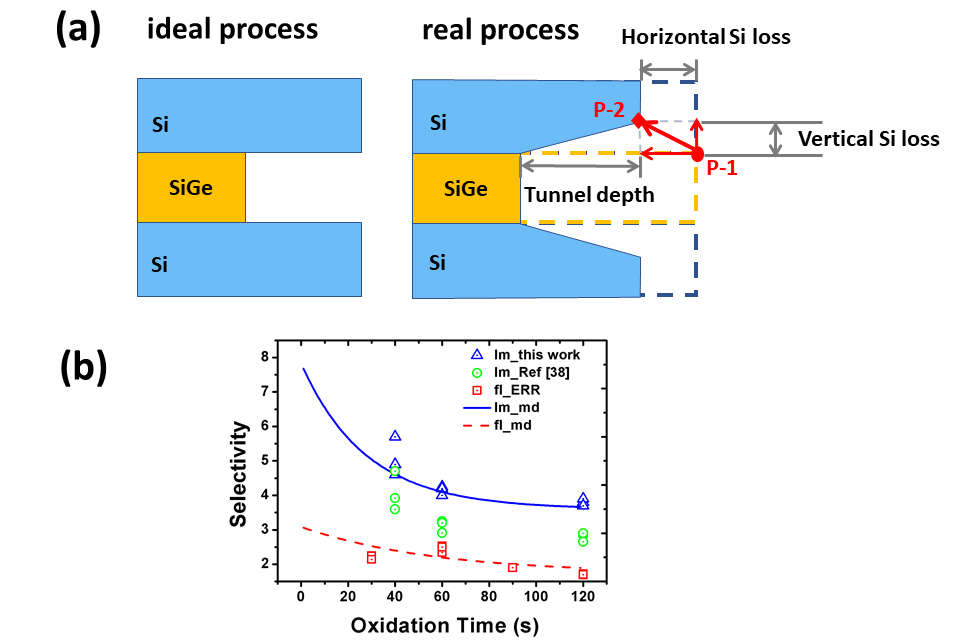
图8。理想工艺和真实工艺的(a)二维原理图,以及eq 6的选择性定义方法。(b)选择性作为氧化时间的函数。开放三角形和圆是选择性计算我们的工作在eq 7和Ref38eq5层压结构(lm)从我们的实验,开放广场蚀刻率比率(ERR)平坦Si0.7Ge0.3和p+硅片(fl)实验,实线是氧化模型计算的选择性曲线(md)eq9,虚线是选择性曲线计算的平面结构氧化模型eq 8。
5.结论
在本文中,通过分离氧化和蚀刻验证了HNO3/HF/H2O蚀刻硅的理论。基于此理论,提出了HNO3-BOE数字蚀刻方法。发现氧化会随时间而饱和。提出了一个氧化模型来描述这一氧化过程和选择性蚀刻。从模型中,得到25%的HNO3和60个蚀刻周期的数字蚀刻中,平面p+ Si的氧化饱和时间和饱和厚度分别为100.0秒和0.47纳米,平面Si0.7Ge0.3的氧化饱和时间和饱和厚度分别为56.6秒和0.81纳米。在叠层结构中,Si0.7Ge0.3的氧化饱和时间和饱和厚度分别为27.6秒和0.72纳米,p+ Si的氧化饱和时间和饱和厚度分别为60.0秒和0.20纳米。Si0.7Ge0.3/p+ Si叠层的饱和选择性为3.6,变化率为4%,使用30.8%的HNO3。模型与我们的实验结果相符。提出了一个修正的选择性计算公式,该公式计算得到的选择性与模型计算得到的选择性相同。数字蚀刻方法可用于获得可控且准确的Si/SiGe隧道深度,饱和REPC约为4 ML。
上一篇: KOH湿法刻蚀下GaN纳米柱的刻面机制
下一篇: 用导电聚合物功能化介孔硅的晶圆级制造