摘要
这是一种制造集成电路封装系统的方法,包括:提供具有导电通孔的硅通孔管芯;在耦合到导电通孔的硅通孔管芯的底部上形成第一再分布层;在耦合到导电通孔的硅通孔管芯的顶部形成阿明 第二再分布层;在sec上制造嵌入式芯片上部结构。第二再分布层包括:将集成电路管芯安装到第二再分布层,在第二再分布层上形成与集成电路. 管芯共面的核心材料层,形成具有耦合到集成电路管芯的接触链路的第一积层,在核心材料建上,以及将元件互连焊盘耦合到接触縫路;以及在第一重新分布层上形成系统互连,用于耦合硅通孔管芯、集成电路管芯、部件互连輝盘或它们的组合。
介绍
在半导体器件领域,器件密度不断增加,而器件尺寸不断减小。这种高密度器件对包装和互连技术缺口的需求也因机械脆性和制造产量问题而变得复杂。相应地,在翻转芯片连接方法中,在模具表面形成一组焊料凸起。焊料凸起的形成可以通过通过焊料掩模产生所需的焊料凸起图案来实现。芯片包的功能包括配电、信号分配、散热、保护和支撑等。随着半导体变得越来越复杂,传统的封装技术出现。如铅框架包装、柔性包装、刚性包装老化技术,不能支持生产包装中具有高密度元素的较小芯片封装的需求。
本文公开提供了一种集成电路封装系统的制造方法,包括:提供具有导电孔的通硅通过模;在与导电孔相连的通硅通过模具的底部形成第一再分配层;通过连接到导电孔的模具在通硅的顶部形成第二再分配层;在第二再分配层上制造嵌入模上部结构,包括:将集成电路模安装到第二再分配层,在第二再分配层上形成与集成电路模共平面的核心材料层,形成在核心材料层上具有与集成电路模具接触连接的第一堆积层,以及与连接连路的耦合组件互连垫;并在第一红色层上形成系统互连,用于耦合通硅通模、集成电路模具、组件互连垫或它们的组合。
实验
其中展示出了使用本文第一实施例的多芯片封装700的截面图。多芯片封装700的截面图描绘了集成电路封装系统100,其具有通过电互连210(例如焊料凸块)直接耦合到部件互连焊盘136的第一堆叠倒装芯片管芯304。粘合剂密封 剂306可以施加在第一堆叠倒装芯片管芯304的有源侧和集成 25电路封装系统100的顶侧之间一集成电路管芯118、第二集成电路管芯120、硅通孔管芯邛2之间形成电连接。嵌入式离散组件通过直接附着第一堆叠倒装芯片管芯304,可以简化制造过程 。分立元件308也可以通过导电粘合剂310直接附着到元件互连焊盘136。这些部件的直接连接可以改善 信号质量并增强多芯片封装700的可靠性。

图 1
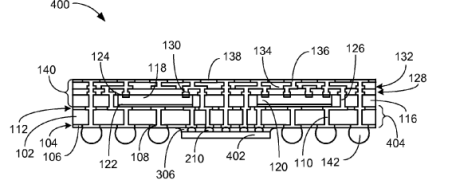
图 2
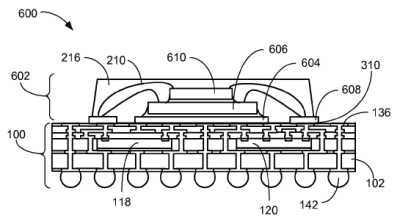
图 3
下一篇: 半导体芯片中的钨蚀刻