引言
氧化锌(ZnO)半导体由于在低沉积温度下具有高电子迁移率,非常适用于有机发光二极管器件。其作为一种新的半导体层取代了薄膜晶体管中使用的非晶硅半导体,在表征方面取得了重大进展。氧化锌的湿法图形化是大规模生产氧化锌薄膜晶体管器件的另一个重要问题。本工作采用电化学分析方法研究了射频磁控溅射氧化锌薄膜在各种湿溶液如磷酸和硝酸溶液中的湿腐蚀行为。还考察了沉积参数如射频功率和氧分压对腐蚀速率的影响。
实验
利用射频磁控溅射系统在玻璃衬底上沉积氧化锌薄膜。沉积后立即测量沉积薄膜的厚度。用轮廓仪测量厚度。残余应力测量通过记录沉积前后硅衬底的曲率来进行。薄膜的应力由斯通尼公式得到。电阻率是通过探针站使用传输线方法在氧化锌薄膜上沉积金属薄膜后获得的。
在包括硝酸(0.1M)、磷酸(0.1M)、盐酸(0.1M)和乙酸(0.1M)的酸溶液中浸泡5秒钟后,用T轮廓仪从厚度梯度经时间测量膜的溶解速率。
结果和讨论
氧化锌薄膜是通过溅射法制备的,这种方法可以很好地控制薄膜的厚度、均匀性和成分。溅射沉积薄膜的结构和性能受到溅射参数的强烈影响,如气体、压力、功率、衬底温度、偏压和离子加速能量。已知薄膜的腐蚀行为强烈依赖于薄膜的结构。氧化锌薄膜的生长速率和电阻率随着射频功率和氧压的增加而增加(图1)射频功率越高,氧化锌薄膜的沉积速率越高。随着射频功率的增加,溅射的锌原子或离子通过增强氩离子与氧化锌靶的碰撞而增加。高射频功率下薄膜电导率的下降是由于氧阴离子轰击氧化锌表面的可能性增加。另一方面,随着氧分含量的增加,薄膜的电阻率接近饱和值。
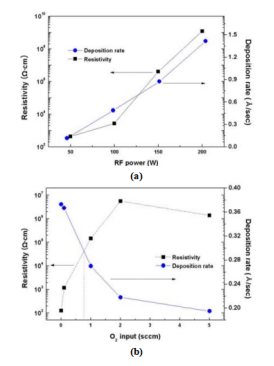
图1 玻璃衬底上氧化锌薄膜电阻率和沉积速率的变化(a)衬底温度为150℃时10毫托的射频功率和(b)衬底温度为50℃时100瓦和10毫托的氧气分压的函数。
薄膜的腐蚀速率随着射频功率和氧分压的增加而降低(图5). 薄膜的腐蚀速率受到薄膜结晶度的强烈影响。随着膜中结晶度的增加,膜的溶解更加有利。

图5.氧化锌薄膜溶解速率对各种酸溶液的依赖性:作为(a)射频功率和(b) O2分压的函数
图5显示了氧化锌薄膜的腐蚀速率对各种酸溶液的依赖性。从上述结果可知,在硝酸(0.1M)中蚀刻速率最快,在乙酸(0.1M)中蚀刻速率最慢。氧化锌的溶解趋势与氧化铟锡薄膜有很大的不同。
总结
研究了射频磁控管溅射的氧化锌薄膜在玻璃基板上的湿式溶解行为。溶解速率随射频功率的增加而增加,在0.5sccm氧分压下表现为最小值。这种行为与氧化锌晶体的结晶度密切。薄膜在硝酸中溶解最快,在乙酸中溶解最慢。
上一篇: 玻璃湿法蚀刻
下一篇: SiC GaN 通孔工艺