新一代GaN/AlGaN高温微波功率电子器件的开发需要具有低栅极泄漏夹断特性的场效应晶体管,特别是在高温下。1这些特性直接影响器件漏极击穿电压、射频性能和噪声系数。过去,有几个研究小组试图使用金属-绝缘体-半导体场效应晶体管(misfet)2-4或金属-氧化物-半导体场效应晶体管器件方法来实现栅极泄漏抑制和出色的夹断特性。然而,所有这些绝缘栅器件的性能水平远低于最先进的AlGaN/GaN hfet。最近,我们在sap- phire上演示了AlGaN/GaN金属-氧化物-半导体异质结构场效应晶体管,并报告了它们的直流特性结果。我们的设计结合了MOS结构抑制栅极漏电流和AlGaN/GaN异质界面的优点,后者提供了高密度、高迁移率的二维(2D)电子气体通道。方法还允许施加高正栅极电压,以进一步增加2D沟道中的片电子密度,从而增加器件峰值电流。
实验
—测量了2×150 m器件的20 V栅极偏置。还报道了二硫化钼的微波和高温性能。我们的金属氧化物半导体场效应晶体管的内置沟道是由AlGaN/GaN界面上的高密度2D电子气体形成的,就像普通的AlGaN/GaN场效应晶体管一样。然而,与HFETs相反,金属栅极通过薄的二氧化硅薄膜与AlGaN阻挡层隔离。因此,金属氧化物半导体场效应晶体管的栅极更像金属氧化物半导体结构,而不是常规金属氧化物半导体场效应晶体管中使用的肖特基势垒。由于适当设计的AlGaN阻挡层被电子转移到相邻的氮化镓层而完全耗尽,金属氧化物半导体场效应晶体管中的栅极绝缘体由两个连续的层组成:二氧化硅膜和AlGaN外延层。这种双层绝缘体提供极低的栅极漏电流,并允许较大的负向正栅极电压摆幅。由于宽带隙和AlGaN势垒的完全耗尽,在栅极电压高达+10伏。我们的模拟以及下面讨论的电容-电压(C-V)和电流-电压(I-V)特性证实了寄生通道的不存在。器件外延层结构(见图1插图)是通过低压金属有机化学气相沉积(MOCVD)在绝缘4H–SiC衬底上生长的。用于该结构的所有铝镓氮/氮化镓层都是在1000℃和76托下沉积的。首先在1000℃的温度下生长50纳米氮化铝缓冲层,然后生长0.4微米绝缘氮化镓层和50纳米氮氮化镓层,估计掺杂水平为(2–5)×1017厘米-3。
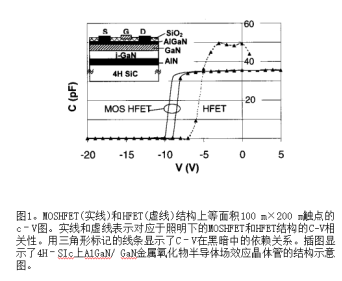
在ture上覆盖一层30纳米的Al0.2Ga0.8N阻挡层,该阻挡层掺杂了大约2×1018cm-3的硅。在该结构的所有层的生长过程中,我们还存在低水平的三甲基碘(TMI)通量。我们认为,铟表面活性剂的存在有助于通过引入痕量铟来改善表面和界面粗糙度。测量的室温霍尔迁移率和载流子浓度分别为1150 cm2/V·s和1.2×1013cm-2。
然后使用钛(200)/铝(500)/钛(200)/金(1500)作为源极-漏极欧姆接触来制造晶体管器件。这些在850℃硝基环境中退火1分钟。能量为10,50,
然后使用100千电子伏和(1–2)×1015厘米-2的剂量进行器件隔离。在栅极制造之前,使用以下方法在部分异质结构上沉积10纳米二氧化硅层
等离子体增强化学气相沉积。这个层的厚度,是从有和没有二氧化硅层的区域的1兆赫的碳-钒测量中提取的。在图1中,我们包括HFET区域上100 m×200 m焊盘的C–V图。
这里是氧化物和非氧化物区域上等面积焊盘的电容,二氧化硅介电常数。使用图1的数据和等式。(1)二氧化硅厚度dOX估计为7纳米。这与从沉积速率预期的10 nm的dOX值相当一致。在图1中,我们还包括在强白光照明下测量的C–V特性。如所见,对于HFET结构(没有二氧化硅层),明暗的碳-钒曲线实际上是重合的。然而,对于金属氧化物半导体场效应晶体管结构,测量到阈值电压偏移δV ~ 1V。
然后我们在有和没有二氧化硅的区域都制作了铂(200)和金(1000)栅极。闸门长度和宽度分别为2米和100米。图2显示了在氮化镓/氮化镓金属氧化物半导体场效应晶体管栅极下有氧化层的器件的测量伏安特性。图2的数据是针对具有5 m的源极-漏极间距和2 m的栅极长度的器件。如图所示,在+9 V的正栅极偏压下测量了接近1.3 A/mm的最大器件电流。此外,器件周围完全被夹断
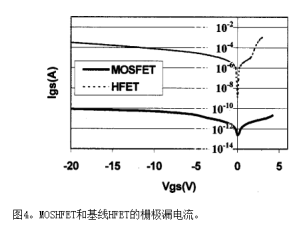
幅和更高的线性度。原则上,这应该会导致更小的互调失真、更小的相位噪声和更大的动态范围。在图4中,我们显示了具有相同几何形状(2 m×200 m栅极面积)的两种器件类型的栅极漏电流。数据显示,在室温下,在-20V栅极偏置下,金属氧化物半导体场效应晶体管的漏电流低至100帕,比具有相似栅极尺寸的HFET晶体管小大约6个数量级。在25–300℃的温度范围内测量了AlGaN/GaN MOSHFET的夹断特性。在栅极电压Vg下测量了室温下低至0.15 nA/mm、250℃下低至38 A/mm的夹断电流
=—15伏,漏极偏置为10伏。即使在高达300℃的温度下,夹断电流仍约为10毫安/毫米,大约小两个数量级
大于最大饱和电流。在高达300℃的最大饱和电流下没有观察到退化。图3和图4的结果清楚地证明了将我们的器件用于高压、高温应用的潜力。
我们还使用惠普-8510 S参数分析仪测量了作为频率函数的电流增益。对2 m栅金属氧化物半导体场效应晶体管和HFET晶体管分别测量了8.2和5.9千兆赫的截止频率。请注意,乘积值与最先进的最高报告值相比也非常有利。
我们还比较了HFET器件的最大输出射频功率。负载牵引测量是在2千兆赫下使用莫里微波自动匹配调谐器系统进行的。在相同的偏置条件下,30伏漏极偏置和-1.5伏栅极偏置,测量到两种器件类型的最大功率约为2瓦/毫米。因此,我们的数据清楚地表明,器件方法保持了高频和高功率性能。我们认为,金属氧化物半导体场效应晶体管的射频功率特性可能远远超过金属氧化物半导体场效应晶体管。栅极偏置可以优化,以允许更高的输入电压和通道电流摆幅。
上一篇: 用于光掩模清洁的两种兆声波装置
下一篇: 氧化锌半导体在酸溶液中湿性能的研究