有机化合物
由于存在挥发性有机溶剂、清洁剂和聚合物建筑材料的脱气,洁净室中无处不在的有机化合物通过空气污染或有机光刻胶 (PR) 的残留物造成表面污染。有机物的严重污染,例如在 PR 去除不完全时发生的污染,会在高温工艺步骤中留下形成碳的残留物,从而影响器件产量。这些碳残留物可以形成核,其表现为颗粒污染物。残留在 PR 化合物中的少量残留金属可以被困在这些碳残留物的表面上。可以使用和其他高效 PR 清理方法去除 PR 残留污染物,
由于无处不在的挥发性空气污染物造成的有机污染也需要从晶片表面去除,这些污染物的存在会阻碍稀氢氟酸溶液去除天然氧化物,从而在栅极氧化物与衬底和栅极之间产生不良的界面。不良的界面特性会严重降低栅极氧化层的完整性。表面上有机化合物的存在会影响热氧化和 CVD 工艺的初始速率,从而导致薄膜厚度发生未知的变化。SC-1 清洁通过过氧化物氧化和 NH 4溶剂去除这些有机残留物。SC-1 清洁剂会缓慢去除任何天然氧化物,并用过氧化物氧化作用产生的新氧化物替换该层。近年来,溶解在去离子水 (DIO3) 中的臭氧越来越多地用于替代旧的 Pirhana 和 SC-1 清洁剂,作为去除有机污染物的“绿色”和更安全替代品。
无机化合物
由于含磷阻燃剂的脱气或工艺工具中的掺杂剂残留等影响,晶圆表面可能会出现含有硼和磷等掺杂剂原子的化合物。如果在高温处理之前没有将它们从晶圆表面去除,这些元素会迁移到衬底中,从而改变目标电阻率。其他种类的挥发性无机化合物,如胺类、氨类等碱性化合物和硫氧化物等酸性化合物, 如果它们存在于基板表面上,也会在半导体器件中产生缺陷。酸和碱会导致化学放大抗蚀剂的碱性或酸性发生意外变化,从而导致图案生成和抗蚀剂去除出现问题。这些化合物具有高反应性,并且很容易与其他挥发性环境化学物质结合。由于在基板表面形成化学盐而产生颗粒和雾度,通过 SC-1 和 SC-2 清洁的联合作用,可以从基材表面去除吸附的酸性和碱性物质。
原生氧化物
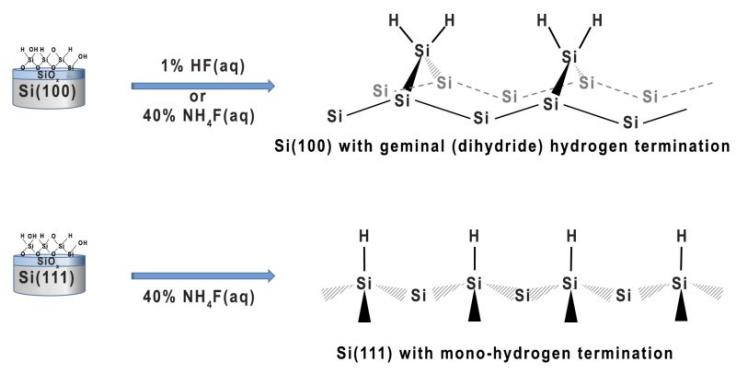
图1
与许多元素固体一样,硅通过与周围空气中的氧气和水分反应,在其表面自然形成一层薄薄的氧化材料。该层的化学组成没有明确定义,或多或少是 Si-O-Si、Si-H 和 Si-OH 物质的随机聚集。这种自然氧化物在硅表面的存在导致半导体器件制造中的问题,因为它会导致难以控制非常薄的热氧化物厚度的形成。在薄栅极氧化物形成过程中存在于衬底上的任何天然氧化物都会通过结合羟基来电削弱栅极绝缘体。此外,如果接触焊盘的硅表面存在原生氧化物,则会增加该接触点的电阻。在过去的 50 年里,我们对硅原生氧化物的性质及其对器件性能影响的了解大大增加。这些研究发现,在去离子水 DI 中的非常稀的 HF 溶液或氟化铵 NH 的稀溶液4 F、HF 和去离子水(缓冲氧化物蚀刻,BOE)完全去除硅的天然氧化物,如图1所示,留下氢封端的清洁硅表面。