我们开发了一种InAlAs/InGaAs异质高电子迁移率晶体管器件制造工艺,其中栅极长度可以在0.13 μm–0.16 μm范围内调节,以适应预期的应用。核心工艺是一个两步电子束光刻工艺,使用三层光刻胶和柠檬酸刻蚀工艺。开发了一个电子束光刻工艺,用于制造T形栅极电极,具有精细的栅极足和相对较大的栅极头。这是通过使用三层光刻胶和两步电子束曝光和显影实现的。柠檬酸基栅极凹槽刻蚀是湿法刻蚀,因此确保刻蚀均匀性和工艺可重复性非常重要。通过考虑涉及凹槽刻蚀的电化学反应来设计器件布局,并找到了优化的刻蚀条件,从而开发了可重复的栅极凹槽刻蚀工艺。使用所开发的栅极电极工艺技术,成功制造了各种单片微波集成电路,包括可在28 GHz到94 GHz频率范围内使用的低噪声放大器。
一、介绍
各种实现未来信息和通信的半导体技术是最重要的工业增长引擎,不仅现在如此,未来也是如此。人们对这些应用的兴趣增加了能够可靠地制造出具有优越特性、能在更高频率下工作的电子设备的半导体技术的重要性。在电子设备中,高电子迁移率晶体管(HEMT)由于其在毫米波或亚毫米波频带下的操作而引起人们的关注,被视为关键元件。这些晶体管在高增益、低噪声和优异的超高频特性方面具有应用,被用于雷达、导引头、光谱仪和未来的千兆级移动通信技术中。当将异质缓冲层应用于GaAs基板时,可以生长出与InP晶格匹配的InAlAs/InGaAs外延层来创建异质HEMT(mHEMT)器件。使用mHEMT器件的单片微波集成电路(MMICs)的结果已见报道。
二、实验
1、外延结构
为了制造InAlAs/InGaAs异质高电子迁移率晶体管器件,使用了具有如表1所示层结构的单晶片(epi-wafer)。通过在4英寸半绝缘GaAs衬底上生长异质缓冲层,采用分子束外延法形成了InGaAs/InAlAs层。在具有Ino.s2Ala4sAs作为肖特基层和Ino.6oGao.4As作为通道层的基本结构中,存在一个掺Si的脉冲掺杂层,掺杂浓度为5.5 x 1012 cm-2,以形成二维电子气(2-DEG)。顶层生长有Ino.s3Gao.4zAs欧姆接触层,以降低源和漏电极的欧姆电阻,掺杂Si的浓度为1 x 101 cm-3。上述结构的epi-wafer由IntelliEPI公司制造,其特性包括2-DEG电荷密度大于3.2 x 1012 cm-2,迁移率大于9800 cm/Ws。覆盖层的方块电阻为80-5 92/sq。
2、设备制造生产
器件制造始于在epi-wafer上使用基于设计布局的掩模形成用于步进光刻工艺的对准键。 此时,还将形成用于器件隔离的光刻胶图案。 所述光刻胶图案用作器件隔离的蚀刻掩模,并且使用由磷酸、过氧化氢和水按1:1:40的比例组成的蚀刻剂将基片蚀刻至200nm深,约90秒。
欧姆电极由Au/Ge/Ni/Ti/Au依次沉积而成,厚度分别为34/17/11.5/11.5/120nm。金属沉积在小于5×10-7Torr的真空条件下使用电子束蒸发器进行。欧姆电极的形成通过在已沉积的晶片上浸入丙酮中以去除沉积在光刻胶上的金属薄膜来完成。
3、T形栅的图案化
在用作低噪声放大器的InAlAs/InGaAs HEMT器件中,通过增加栅电极的横截面积来降低栅极电阻以改善噪声特性是很常见的。 代表实际栅极长度的栅脚制作得很小,而栅极头部被放大,使得横截形状为T形。 制作长为0.13 μm的栅极电极需要使用电子束光刻技术。 此外,为了形成这样的栅电极,需要使用两种或更多种不同的光刻胶进行光刻工艺。 在这项研究中,使用了具有三层结构的光刻胶系统。
图2是由电子束光刻技术制作的三层电子束抗蚀剂系统的横截面示意图。 底层抗蚀剂决定了栅极脚的长和高,涂覆950 PMMA A3,厚度为120nm。 中间层和上层,决定了栅极头的形状,涂覆EL13,厚度为900nm,涂覆495 PMMA A4,厚度为140nm。
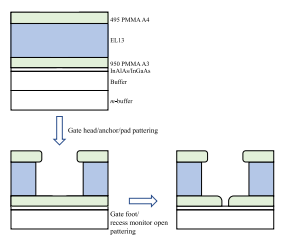
图2使用电子束光刻技术的三层抗蚀剂系统及其加工步骤
在形成所谓的栅极头的光刻工艺步骤中,对图1中指定的栅极头、栅极锚和栅极垫进行曝光,每个优化剂量和束步长。 然后,使用MIBK:IPA(1:1)和MIBK:IPA(1:3)分别开发上PMMA和EL13。 由于各层开发特性的敏感性差异,中间层的EL13被切割,上层PMMA具有悬垂结构。 因此,可以进行剥离工艺。
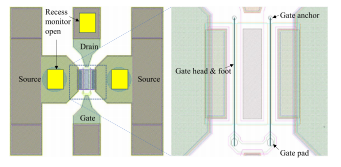
图1凹口监视器开口的位置以及具有双指栅的单元器件的布局
三、结论
对于制造栅长从0.13 μm到0.16 μm的InAlAs/InGaAs异质结双极型晶体管(mHEMT)器件的关键工艺进行了详细说明。介绍了为在高频下表现出合适的特性而制造具有小栅电阻横截结构的器件所采用的光刻工艺。通过三层抗蚀剂的两步电子束光刻工艺实现了T形栅电极的大栅头。为了获得增益和实现高频特性,给出了在栅凹口工艺中必须考虑的蚀刻条件。由于涉及电化学蚀刻反应,应考虑反映该现象的设备设计布局,即在源和漏电极上设置窗口(如凹口监视器开口)以在所有设备中实现均匀的凹口蚀刻。因此,使用优化的InAlAs/InGaAs mHEMT工艺条件,可以可重复地制造均匀的器件。通过制造适合每个使用频率(例如28 GHz、38 GHz、77 GHz和94 GHz)的栅长来制造诸如低噪声放大器、混频器和倍频器的MMIC。

下一篇: 光致抗蚀剂和蚀刻残留物去除:表面的影响