摘要
在微电子设备和集成电路制造过程中,使用不同的化学溶液来清洁氟碳基残留物。由于这些残留物的低表面能和交联性质,以及它们与设备膜材料和结构之间的兼容性,使得清洁和残留物去除过程变得特别具有挑战性。此外,由于刻蚀残留物的成分和化学物理性质的变化,开发有效的清洁化学物质也变得复杂。在这项工作中,通过研究“模型”薄膜和/或图案化的氟碳残留物和清洗化学之间的相互作用,测试了清洗溶液的效率。使用欧文斯-温特方法对这些相互作用进行测量和分析,以确定与观察到的清洁效率的可能相关性。比较固体材料和清洁溶液之间的极性和色散相互作用的相对量,并结合估计残余物和基质之间的分离能作为一个应用的函数。
一、介绍
在集成电路制造中,氟碳基等离子体蚀刻被用于在后端线路加工序列中制作通孔和互连线的介质层图案。使用标准光刻方法与光敏聚合物进行图案定义。然后,氟碳基等离子体蚀刻用于将图案转移到介质材料中。为了实现各向异性蚀刻,在特征的侧壁上沉积了薄氟碳层,从而抑制了横向蚀刻。 此外,氟原子和氟碳离子轰击光敏抗蚀剂表面,导致形成碳化、氟化的地壳。 在后续加工步骤之前,必须去除这种侧壁和光敏抗蚀剂/地壳残留物。 不完全去除残留物会导致后续薄膜层的附着力差、材料污染以及尺寸控制不当。
完全残留物的去除经常受到几个因素的阻碍。侧壁残留物和外壳中的交联阻碍了简单的溶剂溶解。氟碳材料具有众所周知的低表面能和惰性,这使得大多数传统水化学物质无法完全有效地去除残留物。最后,等离子体环境可能导致残留物对基底产生强烈的粘附作用,从而改变现有的界面张力。残留物的化学结构也强烈依赖于工艺和设备,这使得开发适用于广泛蚀刻化学物质和蚀刻条件的去除技术变得更加复 杂。
成功的残留物去除方法通常包括等离子体处理和液体处理步骤的组合。基于氧的等离子体和强氧化性液体化学物质能够裂解碳-碳键,从而实现成功去除。基于含氟离子的半水溶液的其他化学物质被认为可以蚀刻底层基底或攻击基底和残留物之间的界面,从而促进通过剥离去除。其他有效的去除方法包括使用选定添加剂的溶剂基方法和基于氢/氮的非氧化性等离子体。显然,随着含有有机物的低介电常数材料在制造工序中的广泛应用,由于材料兼容性问题,强氧化性化学物质的使用将受到抑制。
二、实验
“模型”氟碳残留物——“模型”氟碳残留物既可以通过Air Products and Chemicals,Inc.(位于宾夕法尼亚州阿伦敦市)生成,也可以通过在乔治亚理工学院的平行板反应器中进行的等离子体辅助沉积形成。这些平面蚀刻残留样本是将硅片置于C4F8基氟碳等离子体工艺中暴露一定时间而形成的。乔治亚理工学院典型的沉积条件是C4F8 30 sccm,O2 6 sccm,Ar 120 sccm,衬底温度120°C,功率300 W,压力0.79 Torr。在这些条件下,氟碳薄膜的沉积速率为2.1±0.5 nm/s。
沉积的残留样本与在等离子体蚀刻图案样本期间产生的光刻胶顶部的氟碳外壳相似,从X射线光电子能谱(XPS)分析的角度看,无论是膜组成还是键结构都很相似。模型残留样本给出了与位于通孔底部的残留物相当的键结构;本项研究未测量侧壁残留物的成分。
这些模型残留薄膜的厚度在100至200纳米之间。XPS测量表明,Air Products样本的成分为45%碳、50%氟和5%氧,在乔治亚理工学院生成的样本的成分为48%碳、46%氟、1%氮和5%氧。样本被切割成1平方厘米的样本,并采用各种化学溶液处理。
三、结果与讨论
表面特性——未知表面通过测量两种不同探针液体(例如二碘甲烷和水的接触角来表征。二碘甲烷只参与色散相互作用,而水既参与色散相互作用,又参与极性相互作用。所研究各种表面的结果如表I所示。通过将硅衬底暴露于先前描述的氟碳等离子体环境中,产生了两种类型的“模型”残留物。根据Owens-Wendt模型计算了Air Products,Inc.提供的膜的表面能,为22.6 mJ/m2,色散贡献为85%。乔治亚理工学院生成的相当膜的表面能为17.4 mJ/m2,色散贡献为92.2%。如实验部分所述,膜的组成和键结构非常相似;这两种膜都具有高度氟化的表面。尽管如此,由于键结构和组成的微小差异,其表面性质和溶液相互作用仍有所不同。
这种分析的结果可以与每种溶剂的Hansen溶解度参数进行比较,该参数代表了溶剂和聚合物之间的类似的溶剂色相尺度。将分子相互作用分离为色散、极性和氢键值,其平方和的平方根等于Hildebrand溶解度参数。如前所述,表面能量的色散和极性部分的百分比贡献与溶剂参数的匹配是有效残留物去除的重要考虑因素。由于模型和图案蚀刻残留物的表面能量都具有高色散成分贡献,我们还检查了溶剂参数的色散成分。每个数据点都通过其总值进行归一化——Hansen参数通过Hildebrand溶解度参数进行归一化,而Owens-Wendt色散值通过总表面张力进行归一化。比较的示图如图1所示,显然,这些值具有相当好的相关性。
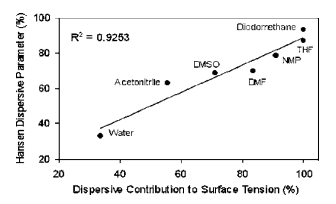
图1 选定溶剂的表面张力色散成分与该溶剂的Hansen色散参数之间的相关性。
Owens-Wendt分析的优点是,可以通过测量单个接触角来执行溶剂表征,假设已知液体表面张力。Hildebrand参数与溶剂的内聚能密度的平方根有关,而内聚能密度可以从蒸发热中确定。然而,对于几个原因,确定Hansen或Hildebrand参数对于固体或表面更为复杂。例如,通常难以测量薄膜的蒸发热,而进行的测量是基于薄膜溶胀的估计或在薄膜可溶于真实溶剂的情况下进行云点测定。这些测量既复杂又耗时。
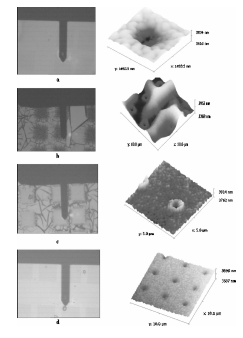
图2 a. 在暴露于任何清洁化学物质之前,pattern residue是厚的,覆盖了大部分的通孔开口,形成了一个嵌入的坑。
b. 暴露于NMP之后,pattern residue在通孔区域包括通孔入口附近区域显著膨胀。
c. 在暴露于NMP之后,用MeOH漂洗可以消除聚合物在通孔之间的膨胀,但侧壁上的刻蚀残留物仍然膨胀。
d. 暴露于去离子水后,没有观察到残留物表面的明显形态变化。
图2显示了图案残留物在暴露于溶剂之前(2a)、暴露于NMP之后(2b)、暴露于NMP之后用MeOH漂洗(2c)以及暴露于水之后(2d)的光学和AFM图像。如图2所示,未暴露于任何溶剂的原始残留物很厚,覆盖了大部分通孔开口,从而形成嵌入的坑。暴露于NMP会导致通孔区域包括通孔入口附近区域显著膨胀。似乎通孔结构阻止了剥离,可能是因为残留物在化学上与侧壁相连。在图案之间的开放区域观察到残留物的广泛开裂。从化学上讲,侧壁残留物与模型残留物薄膜最为相似;然而,在溶剂暴露时并未观察到类似的溶解行为。这些差异可能是由以下事实引起的:底层材料不同(Coral与二氧化硅),或者用于生成样本的不同反应器中的等离子体/自由基通量不同。此外,底层低k材料的有机性质可能导致残留物粘附性增强,这与观察到的结果一致。在暴露于NMP后用MeOH漂洗(图2b)可以消除聚合物在通孔之间的膨胀。然而,与初始形态的比较表明,附着在侧壁上的刻蚀残留物仍然膨胀,从而形成一个突出的坑。暴露于水并未引起残留物表面的明显形态变化(图2d)。
添加剂对去离子水(DIW)和N-甲基吡咯烷酮(NMP)的影响以及它们与各种表面的相互作用。特别地,它提到了向光阻剂开发者溶液中添加盐对光阻剂溶解的显著影响。这表明添加各种盐可能对去除去离子水和NMP溶液中的含氟碳基残留物有类似的效果。
然后,它评估了一系列0.1 M盐溶液以及上述的含氟碳和残留物的表面特性,使用的是Owens-Wendt分析技术。这些盐包括:锂四氟硼酸盐(LiBF4)、铵四氟硼酸盐(NH4BF4)、四丁基铵四氟硼酸盐(TBABF4)、氟化铵(NH4F)、四丁基铵氟化物(TBAF)和四甲基乙酸铵(TMAAC)。选择这些盐是为了研究阴离子/阳离子大小和化学功能性的影响,并允许与Hofmeister系列进行比较。
Hofmeister系列是一个在物理化学中非常重要的概念,它涉及到不同离子对水溶液表面张力的影响。这一系列按照不同离子的"亲水性"或"疏水性"排序,这影响了这些离子如何与水溶液的表面(或其他极性分子)相互作用。
四、结论
初步研究表面化学和物理性质表明,通过极性和分散组件的匹配,溶剂和表面之间的化学相似性允许对清洁混合物进行初步评估,以去除等离子体蚀刻后的残留物。向DI水或NMP中添加离子盐会降低整体表面张力,并改变描述相互作用的极性和分散组件的分布。含氟盐在水和NMP中表现出相反的行为,这可以归因于盐的溶剂化和水解的差异。阴离子的性质对残留物的去除比阳离子的性质/大小更为重要。然而,对于所研究的溶剂、盐和表面,Hofmeister系列不能与清洁结果进行准确的相关性。将分离能量变化进行估算,作为特定清洁溶液中残留物与基底之间相互作用的一个函数,可以很好地解释观察到的残留物去除结果。虽然本研究中使用的模型氟化层由于其复杂结构和依赖于加工历史的依赖性,不能精确模仿实际的等离子体蚀刻后残留物的行为,但它们可以用来研究各种溶剂和添加剂与表面的相互作用,从而为清洁化学品的配方提供指导。