Caria是一种纳米颗粒,它被用来快速和选择性地去除SiO2薄膜。当在SiO2薄膜表面进行抛光时,它与Ce-O-Si键结合,化学反应为(-Ce-OH + -Si-O- ↔ Ce-O-Si- + OH-)。这种化学反应发生在硅氧化物薄膜表面,用于深沟隔离(STI)和层间介质(ILDs)抛光。吸附在SiO2薄膜表面的Ce-O-Si键比其他残留物更难去除,而且比以前更难去除更小的尺寸的铈氧化物纳米颗粒。
用于有效地去除SiO2薄膜表面上的铈氧化物纳米颗粒,有两种方法:第一种方法是优化混合比例的氢氧化铵(30wt% NH4OH)和过氧化氢(30 wt% H2O2)溶液,以最大限度地提高过羟基离子(HO2-)的浓度。这种方法旨在通过过羟基离子破坏Si-O键,从而去除纳米颗粒。第二种方法是开发含有化学添加剂的清洁溶液,以阻止已分离的铈氧化物纳米颗粒重新附着到SiO2和Si3N4薄膜表面。
混合了硫酸(H2SO4)和过氧化氢(H2O2)的溶液,这种溶液被称为SPM或piranha溶液,它因为不仅能去除有机残留物,还能在化学机械平坦化(CMP)之后用强氧化剂清洗铈氧化物纳米颗粒,因此在半导体设备制造的清洁过程中受到了极大的关注和使用。特别是,在喷射喷嘴直接混合化学物质下的单晶片清洗方法在实践中逐渐应用于清洁过程。
使用概率密度函数(PDF)和流体体积(VOF)模型分别描述化学反应和溶液界面捕获,其中混合物分数和溶液的体积分数被运输。
用Lee模型来描述相间的质量相互作用,而在描述硫酸溶液热时,本文介绍了化学能守恒体系,并在能量方程中作为源项,可以描述如下。本文将商业平台ANSYS流畅性与用户定义函数(UDF)相结合。
实验
为了验证仿真结果,实验装置的准备工作如图1所示。硫酸和过氧化氢溶液将被供给到SPM喷嘴,并通过注射泵进行定量控制。在SPM喷嘴的内部和出口将放置两个温度传感器。同时,将热成像摄像机观察晶片表面喷涂的SPM溶液。监测到的温度值将与模拟结果相关联,作为一种验证方法。
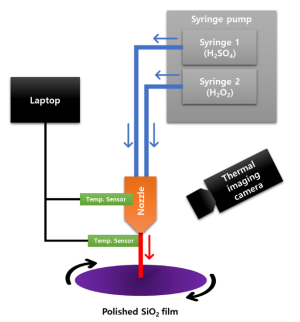
图1验证抛光二氧化硅上硫酸和过氧化氢反应的期望和清洗效率的实验设置
论述
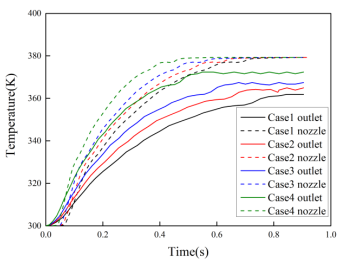
图2 出口和整个SPM喷嘴的平均温度发展
情况1-情况4是指硫酸(99wt%硫酸)与过氧化氢(30wt%过氧化氢)之间的流量比,分别为3:1、3.5:1、4:1和5:1。反应过程的趋势显示基于模拟结果,温度快速升高和保持稳定,这可以解释为硫酸稀释过程的热效应,这个过程中温度变化的主要因素,以及严重放热过程引发的相变。随着硫酸流速的增加,沉降时间减小,而出口处的平均温度升高。
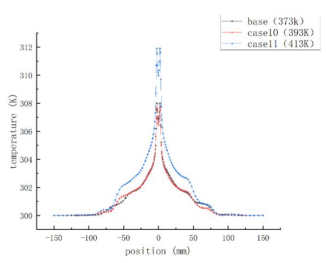
图3 SPM溶液按温度373K(黑色)、393K(红色)和413K(蓝色)条件下的温度分布
对于清洁过程来说,SPM溶液的厚度均匀性与旋转速度有关,这可以通过引入更强的离心力来解释。温度分布与混合溶液的流率和温度密切相关。晶片表面上的温度分布与薄膜的厚度具有相同的趋势,这可以通过晶片与高温溶液之间的热传导来解释。除了输送的流体质量外,流速的影响可能还来自未来工作中研究的湍流强度。
结论
关于硫酸(99wt% H2SO4)和过氧化氢(30wt% H2O2)在SPM喷嘴中的化学反应和流动态的模拟。
首先,我们建立了硫酸和过氧化氢在SPM喷嘴中的化学反应和流动态的数值模型,并使用有限体积法(FVM)进行离散化。
然后,我们发现混合比例对硫酸和过氧化氢混合溶液的热效应和SPM溶液的均匀性有重要影响,而SPM溶液的流速对SPM溶液的均匀性也有影响。
最后,我们通过实验验证了这些模拟结果。
因此,我们可以得出结论:混合比例和SPM溶液的流速是影响SPM溶液均匀性和热效应的重要因素,从而影响清洁过程的效率。
上一篇: 可转移单晶AlN纳米膜的合成及特性
下一篇: 微刻工艺中光刻胶膜均匀性的控制