摘要
该工作致力于开发一种结合表面形貌和晶体结构分析的方法,用于分析晶体硅。 为了证明该方法的适用性,对多晶硅样品进行了一系列化学操作,如抛光和纹理处理。 这些样品用WLI和Laue技术进行了预分析和后分析,通过实验数据可以构建晶体取向到蚀刻速率依赖性的映射。 该研究说明了组合技术作为原子力显微镜(AFM)和电子背散射衍射(EBSD)等现有技术的替代技术的优势。
背景的艺术和状态
现代半导体硅工业和研究领域使用了多种表面分析技术来研究晶体结构、晶体取向、晶体形态、晶粒结构和二维缺陷(晶界、孪晶等)。 常见的分析技术包括扫描电子显微镜(SEM)、原子力显微镜(AFM) 和电子背散射衍射(EBSD) 。晶体硅表面特性和晶体学对太阳能电池加工操作的效率有很大影响,如表面的纹理加工、抛光和蚀刻。
触针式轮廓仪和AFM等扫描技术对于“直接”表面扫描是重要的技术。触针式轮廓仪是广泛使用的表面形貌测量仪器之一,其工作原理简单,基于将机械响应转换为电信号。这种技术可用于相对较大的样本区域,最大可达300毫米。然而,该技术的横向分辨率最大限制为50纳米。在现代硅工业中,硅的形态处理具有纳米级尺度,为了观察孔隙率、纳米柱等形态变化,需要更精确的技术。
因此,虽然触针式轮廓仪等技术在某些应用中可能仍然有用,但在需要更高分辨率和精度的现代半导体硅工业和研究领域中,这些技术可能不再足够。对于纳米级形态变化的观察和研究,需要更先进的技术来获得更准确的结果。
方法详细信息
本研究中结合使用的两种技术中的第一种是劳厄扫描。这种仪器作为EBSD扫描的大面积替代方案,用于获取mc-Si晶圆表面上单个晶体的晶体取向。
LAUE工具的工作原理基于X射线束扫描。为了获得扫描样本图,劳厄工具对样本进行了一系列光学图像采集,以识别可能的晶粒轮廓,并为后续X射线扫描创建一个地图。样本表面上的晶体用颜色表示,颜色代表晶体在样本上的方向变化。在扫描过程中,样本表面每个晶格平面的背散射衍射图案是由X射线产生的。根据布拉格定律,在界面处通过波长和晶格间距匹配,测量所有晶体取向。此外,这些方向通过欧拉角(晶体的旋转)和样本坐标系来表示。因此,劳厄工具生成一个包含样本表面坐标及其相应欧拉角的文件。

图1使用劳厄工具扫描多晶硅晶圆获得的图像
首先,将样本放置在舞台上(图2)。其次,劳厄舞台在Z方向上移动,以在扫描器和样本之间设置最佳距离。劳厄工具的扫描程序可分为两种模式:i)光学和ii)X射线(劳厄)扫描。在光学模式扫描期间,用白光照亮样本表面,并使用内置显微镜进行扫描,以区分样本上的不同晶粒。所有检测到的晶体随后由X射线进行扫描,以获得当前晶格的背散射衍射。结果测量所有晶体取向并创建样本的hkl色图。
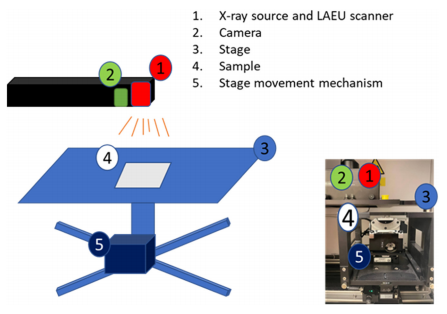
图2 LAUE工具的原理图与真实的视图
白光干涉法(WLI)是用于定量测定蚀刻c-Si晶圆表面粗糙度的互补方法。WLI的工作原理基于样品表面光的反射。从表面反射回来的光合成为表面形状,反射光的变化是不同样品表面区域(晶体)高度变化的一个指标。因此,与AFM相比,WLI分析可以在更宽的晶圆面积上区分高度差异,即其分辨率更接近光学显微镜。此外,WLI技术可以获得样本的二维和三维形貌,同时具有100纳米尺度的横向分辨率。WLI的主要优点是:i)非接触式和ii)非破坏性分析,消除了损坏和污染样品或其表面的任何风险。图3显示了使用WLI扫描的多晶硅晶圆在蚀刻和非蚀刻条件下的详细地图。

图3 白光干涉法扫描多晶硅表面蚀刻前(a)和蚀刻后(b)的示例
方法验证
将上述两种工具组合起来,以确定多晶硅晶圆中各个晶体对不同蚀刻溶液的蚀刻反应。该方法包括主要的实验步骤:晶圆抛光、劳厄工具扫描、白光干涉法扫描、湿化学蚀刻、第二轮白光干涉法扫描,如图3所示。
样品制备(Si表面的抛光)
为了准备切割后的多晶硅晶圆样本,需要进行化学清洗和随后的抛光。多晶硅晶圆通过激光切割成4×4cm²的小块,并在65-70℃的RCA1溶液中清洗并干燥。样本进行两次随后的湿化学抛光处理,具体如表1所示。
白光干涉法和劳厄扫描技术相结合,作为研究方法已经成功应用,详细内容请参阅我们的工作。在我们的研究中,对多晶硅晶圆上不同晶体取向的几种不同蚀刻溶液的蚀刻速率进行了测定。按照第2节所述的程序,首先对样本进行劳厄扫描。此外,对同一样本的几个区域进行扫描电子背散射衍射 (EBSD) 以确认劳厄扫描的结果。图4显示了Laue(a)扫描和EBSD(b,c)扫描。

图4 (a)样品的Laue工具晶体图;(b)(c)同一样品的EBSD扫描和索引区域
总结
Laue和WLI扫描的结合可以获得大量的c-Si表面分析数据集。所开发的方法为多晶硅晶圆的整个区域提供了晶体学扫描。WLI的额外使用可以构建晶体表面图,估算大面积的表面粗糙度。可以量化诸如抛光、纹理、反应离子刻蚀、金属辅助化学刻蚀等表面处理的效果。结合使用此数据和诸如MTEX的软件工具,可以量化表面处理(尤其是刻蚀速率)对c-Si表面晶粒取向的影响。此外,白光干涉法也可以作为一种独立的技术应用于单晶晶圆加工中,表征与纹理相关的特征。