硅衬底上的高度规模化 GaN 互补技术
This article reports on the scaling of GaN complementary technology (CT) on a silicon substrate to
push its performance limits for circuit-level applications.The highly scaled self-aligned (SA) p-channel FinFET (a fin width of 20 nm) achieved an ID,max of −300 mA/mm and an RON of 27Ω·mm, a record for metal organic chemical vapor deposition (MOCVD)-grown III-nitride p-FETs.
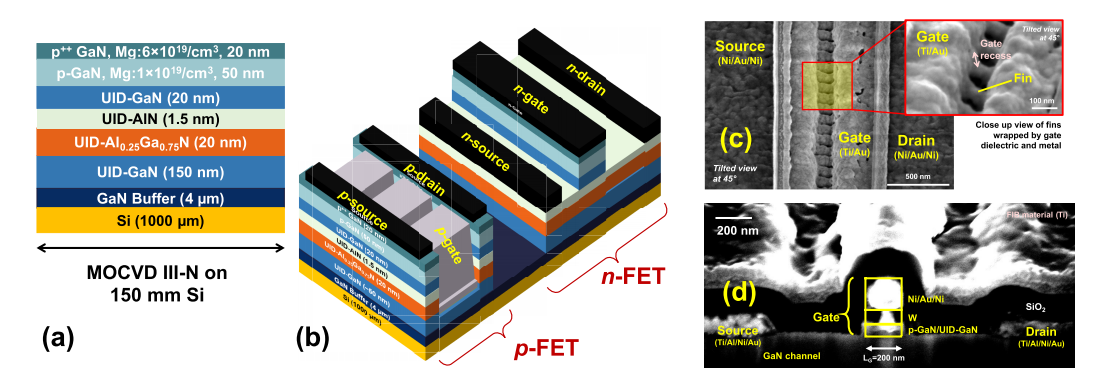
高密度铌酸锂光子集成电路
Here we demonstrate that diamond-like carbon (DLC) is a superior material for the manufacturing of photonic integrated circuits based on ferroelectrics, specifically LiNbO3. Using DLC as a hard mask, we demonstrate the fabrication of deeply etched, tightly confining, low loss waveguides with losses as low as 4 dB/m. In contrast to widely employed ridge waveguides, this approach benefits from a more than one order of magnitude higher area integration density while maintaining efficient electro-optical modulation, low loss, and offering a route for efficient optical fiber interfaces.
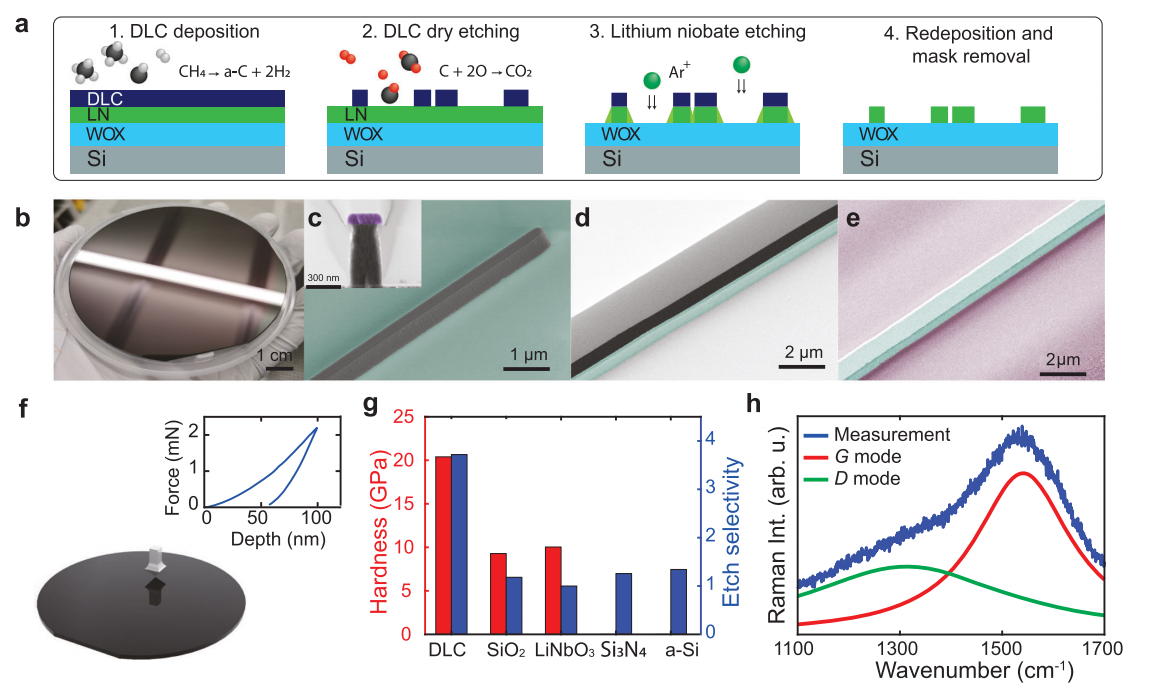
碳化硅的新型光子应用
Silicon carbide (SiC) is emerging rapidly in novel photonic applications thanks to its unique photonic properties facilitated by the advances of nanotechnologies such as nanofabrication and nanofilm transfer. This review paper will start with the introduction of exceptional optical properties of silicon carbide. Then, a key structure, i.e., silicon carbide on insulator stack (SiCOI), is discussed which lays solid fundament for tight light confinement and strong light-SiC interaction in high quality factor and low volume optical cavities.
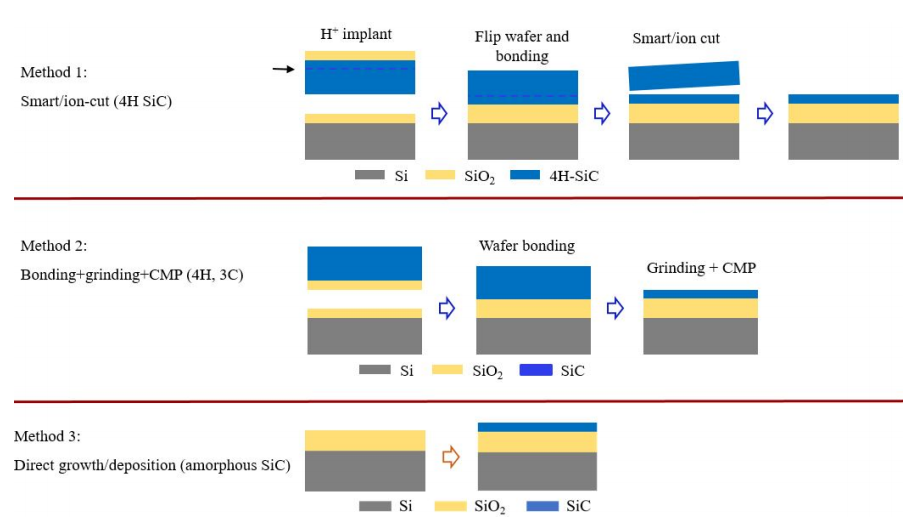
稀有气体对二氧化硅薄膜ACL蚀刻选择性的影响
In this study, we investigated the effect of Ar/He mixing ratio in the tetrafluoromethane/perfluorocyclobutane/Ar/He gas mixture on plasma parameters, SiO2 etching kinetics, and etching selectivity with respect to the amorphous carbon layer (ACL) mask in the inductively coupled plasma system with the low frequency (2 MHz) bias source. It was found that the type of dominant carrier gas does influence the output process characteristics through changes in both ion flux and CFx/F ratio determining the plasma polymerizing ability. In particular, He‐rich plasmas exhibited better performance with respect to the faceting of ACL mask and SiO2/ACL etching selectivity.
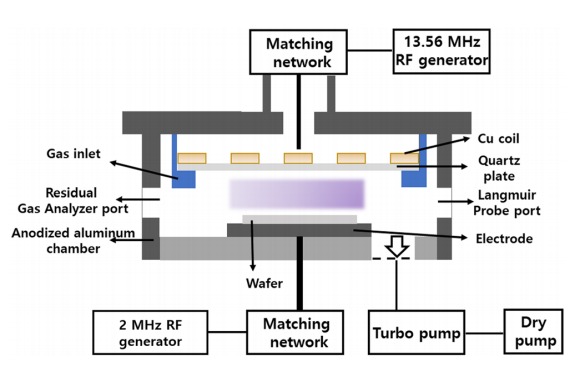
关键词:互补、FinFET、氮化镓、GaN-on-Si、n-FET、p通道场效应晶体管(p-FET)、缩放、自对准(SA)、晶体管、碳化硅、综合光子学、非晶碳层、电感耦合等离子体蚀刻、离子辅助蚀刻、低频偏置功率、铌酸锂、光子集成电路